Транспортные явления.
Наноэлектроника.
Часть 2

До столкновения Е = ?0 + qFl. При столкновении электрон теряет (рассеивает) часть своей энергии? рас < Е0 + qFl. Тогда после столкновения новая (стартовая) энергия электрона будет равна Е = Ео + А?, где АЕ = Е0 + qFl — Е^. Следовательно, стартовая позиция этого электрона перед следующим накоплением энергии от поля будет уже выше, чем Е0. Иными словами, для части электронов избыточная энергия… Читать ещё >
Транспортные явления. Наноэлектроника. Часть 2 (реферат, курсовая, диплом, контрольная)
СТАЦИОНАРНАЯ ДРЕЙФОВАЯ СКОРОСТЬ
Одним из важнейших параметров, определяющих быстродействие полупроводниковых приборов, является дрейфовая скорость носителей заряда. Прежде чем описывать процесс дрейфа электрона в электрическом поле, попытаемся представить феноменологически это движение.

Рис. 7.1. Движение электрона в электрическом иоле:
а — в A-пространстве; б — в координатном пространстве; в наклон энергетических зон При приложении электрического поля F (x) электрон начинает непрерывно ускоряться в направлении поля. Если кристалл идеален (отсутствуют дефекты), то под действием силы F значение квазиимпульса электрона кх будет расти, пока не достигнет кх=п/а (точка А на рис. 7.1, а). Далее значение к уже окажется за пределами первой зоны Бриллюэна, что равносильно появлению электрона в точке А' с кх = - я/а. Не вдаваясь в подробные объяснения, отметим, что по мере приближения к значению кх=п/а эффективная масса электрона становится отрицательной. Это означает, что в координатном пространстве (рис. 7.1,6) электрон, выходя из точки О, сначала ускоряется, затем замедляется при приближении к точке А и, наконец, снова начинает ускоряться, но уже в обратном направлении (двигаясь к точке В), хотя направление и величина внешней силы сохраняются неизменными. При кх= 0 электрон снова окажется в состоянии покоя.
Таким образом, под влиянием постоянного внешнего поля электрон должен в пространстве Е (к) совершать скачкообразное движение вдоль оси кх около начала координат в схеме приведенных зон, двигаться вверх и вниз по периодической кривой ОАВС в схеме повторяющихся зон и колебаться на ограниченном отрезке оси х в координатном пространстве с амплитудой Ах = Д/2qF (x) и частотой Q = qF (x)a/h (здесь Дширина энергетической зоны, а — период решетки в направлении поля).
Однако хорошо известно, что это не соответствует реальному случаю и поведение электрона в реальном кристалле совсем другое. Это различие обусловлено наличием даже в самых совершенных кристаллах примесей и различных дефектов, к числу которых можно отнести и колебания решетки.
Дело в том, что для наблюдения блоховских осцилляций необходимо выполнение чрезвычайно жестких условий слабости рассеяния носителей заряда за период осцилляций (т~фф < Q, здесь тэфф — эффективное время рассеяния, Q — частота блоховских осцилляций).
В обычных условиях за время, необходимое электрону для значительного возрастания энергии под действием электрического поля, он успевает много раз столкнуться с различными дефектами (нейтральными и ионизированными примесями, акустическими и оптическими колебаниями решетки).
Так как масса ионов примесей очень велика по сравнению с массой электрона, соударение между ними носит упругий характер. Электрон при этом практически не меняет своей энергии, изменяется только направление его движения. Аналогичный характер имеет и рассеяние на акустических колебаниях решетки. В этом случае упругость соударений обусловлена большим различием в энергиях «партнеров». Обычно энергия электронов на порядок превышает энергию акустического фонона (h (0A0.1 к0Т, а Ejл = 3/2 кцТ). Следовательно, при взаимодействии с перечисленными дефектами волновой вектор электрона к, как правило, изменяется только по направлению, оставаясь на поверхности равной энергии в ^-пространстве.
Большой вклад в общее рассеяние может дать рассеяние на оптических фононах. Это обусловлено близостью по величине энергий электрона (?зоок — 0.025 эВ) и оптического фонона (йсо0 ж «0.036…0.037 эВ), что значительно повышает вероятность неупругого рассеяния по сравнению с другими механизмами. Понятно, что решающее значение этого фактора проявится при взаимодействии электронов с сильным электрическим полем, когда может произойти увеличение энергии электрона.
Таким образом, движение электрона в кристалле оказывается аналогичным движению молекулы в газе. Электрон, двигаясь в отсутствие внешних полей хаотично, обладает при этом определенной длиной свободного пробега между двумя последовательными столкновениями. Если прикладывается внешнее поле, то на это хаотическое движение накладывается направленный дрейф в реальном пространстве. Естественно, что действительная длина пути, пройденная электроном, оказывается значительно больше пути дрейфа.
Чтобы определить среднюю дрейфовую скорость в поле F, необходимо найти функцию распределения электронов по импульсам, координате и времени — J[k, г, /), например, путем решения кинетического уравнения Больцмана. Хорошо известно, что аналитическое решение этого уравнения возможно только для некоторых специальных случаев. Прежде всего это случай, когда неравновесная функция распределения в электрическом поле отличается от равновесной малым приращением. Уравнение Больцмана упрощается также в стационарном случае для однородного по объему распределения электронов, когда исчезают производные по времени и координате. Часто для решения уравнения Больцмана используют методы последовательного приближения (метод прямой итерации) или метод Монте-Карло моделирования движения электронов в к, г, /-пространствах (импульс, координата, время).
Найденную из решения уравнения Больцмана функцию распределения используют для определения макроскопических параметров полупроводника: тока электронов, их средней энергии и средней по ансамблю электронов дрейфовой скорости Vd в поле F.
На практике наиболее часто используется приближение, при котором так называемый столкновительный член уравнения Больцмана (столкновительный интеграл) удается записать с использованием времени релаксации х (к). Смысл этого параметра легко понять при рассмотрении следующего простого выражения:

где т (к) — время релаксации, в течение которого разность между неравновесной и равновесной функциями распределения после выключения внешнего воздействия (поля) уменьшается в е (~ 2.73) раз.
Обычно приближение времени релаксации является обоснованным, если процессы рассеяния приводят к случайному распределению скоростей (вероятность перехода от Vo к — V или +V одинакова) либо изменение энергии при столкновении невелико. Для качественной и наиболее наглядной оценки изменения дрейфовой скорости и энергии электронов в однородно легированном полупроводнике в сильных электрических полях применяются уравнения баланса усредненных импульса V(l и энергии электрона Е

где Е0 = (Зк0Т)/2 — средняя тепловая энергия в отсутствие внешнего поля F; хР(Е) и Хе (Е) — времена релаксации по импульсу и энергии соответственно.
В условиях стационарности (мы ввели их в начале рассмотрения) можно записать.

г. е. мы считаем, что в течение рассматриваемого промежутка времени энергия электрона и импульс неизменны. Это дает возможность из уравнений баланса получить выражения для времени релаксации по импульсу и энергии в следующем виде:
(индекс s означает стационарное значение).
Именно такими уравнениями пользуются при оценке максимальных дрейфовых скоростей и описании динамики их изменения во времени. Эти оценки обычно сравниваются с результатами компьютерных расчетов методом Монте-Карло, чему посвящено огромное количество работ. Заметим, что эксперименты с использованием ЭВМ обычно легче и дешевле реальных.
Известно, что время релаксации по импульсу, как правило, много короче времени релаксации по энергии, так как упругие столкновения до растрачивания накопленной в электрическом поле энергии могут произойти неоднократно. Это означает, что средняя частота столкновений носителей заряда с центрами рассеяния в кристалле, а следовательно, и дрейфовая скорость также определяются величиной времени релаксации по импульсу.


^(?) — «, ,.
где р = —-—подвижность носителей заряда. Из (7.1.6) видно,.
т*(Е).
что зависимость подвижности от напряженности электрического поля определяется зависимостью!р(Е) через среднюю энергию электрона, зависящую от внешнего поля.
Экспериментальные ВАХ полупроводников позволяют определить р, затем Vj и, наконец, т. Во всех полупроводниках дрейфовая скорость увеличивается с ростом электрического поля только до некоторых максимальных значений, а затем либо насыщается (Si — рис. 7.2, а либо уменьшается (АщВу — рис. 7.2, б).
Как мы увидим далее, зависимость дрейфовой скорости от поля определяется не только механизмами рассеяния, но и структурой энергетических зон.
В валентных или одноатомных полупроводниках, какими являются Ge и Si, основная причина ограничения темпа роста дрейфовой скорости — рассеяние на оптических фононах. В отличие от почти упругого рассеяния на акустических фононах рассеяние на оптических фононах является резко неупругим, и более того, вероятность рассеяния на оптических фононах на порядок выше вероятности рассеяния на акустических фононах.
Как только энергия электрона становится выше энергии оптического фонона, частота рассеяния резко возрастает, а значит, время релаксации резко падает. Частота рассеяния представляет собой вероятность рассеяния электрона с волновым вектором
![Экспериментальные зависимости дрейфовой скорости электронов (кривые 1-4) [1] и дырок (кривая 5) [2] в кремнии {а) и зависимости дрейфовой скорости электронов в GaAs (кривые /.](/img/s/8/19/1469219_7.png)
Рис. 7.2. Экспериментальные зависимости дрейфовой скорости электронов (кривые 1−4) [1] и дырок (кривая 5) [2] в кремнии {а) и зависимости дрейфовой скорости электронов в GaAs (кривые /,.
2) [3, 4] и AlGaAs (кривые 5) [5] (б) от напряженности электрического поля.
к в единицу времени. Это сугубо неупругое рассеяние на оптических фононах ограничивает рост энергии электронов и приводит к насыщению дрейфовой скорости.
Иначе говоря, резкое увеличение частоты столкновений электронов при энергиях выше энергий оптических фононов и увеличение вероятности взаимодействия электронов с этими фононами компенсируют рост тр при дальнейшем.

увеличении электрического поля. Но, как видно из рис. 7.3, время релаксации импульса и энергии, а следовательно, и подвижность электронов для GaAs начинают Рис. 7.3. Зависимости времен падать с дальнейшим увеличением релаксации импульса и энергии от разницы между средней и тепловой энергией в Si и GaAs при Т= 296 К [6] их энергии. Это сильное падение обусловлено еще двумя другими дополняющими друг друга явлениями (механизмами рассеяния): эффектом убегания и междолинным перебросом.
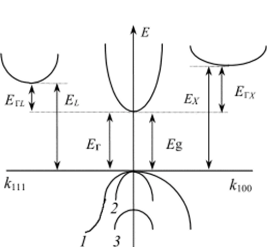
Рис. 7.4. Энергетическая диаграмма для GaAs.
Для описания добавочных механизмов рассеяния необходимо обратиться к энергетической диаграмме GaAs, приведенной на рис. 7.4. Видно, что энергии минимумов L- и X- долин располагаются выше минимума Г-долины. Энергия минимума.
L-долины относительно минимума Г-долины составляет.
ErL *0.3эВ, а-долины — ЕГх ~ «0.47эВ. Междолинный переброс электрона из нижней Г-долины в верхние L- и X-долины происходит, как только энергия электрона в Г-долине достигает значений, близких к минимумам верхних долин. Центральная Г-долина имеет большую кривизну по сравнению с боковыми L- и-долинами. Это означает, что в ней эффективная масса меньше, а подвижность больше, чем в L и X. Но в то же время вследствие большей эффективной массы плотность состояний в боковых долинах много выше, чем в центральных.

По этой причине, если электроны в Г-долине приобретают энергию порядка энергии боковых минимумов, то вероятность найти его в боковой долине становится значительно выше, чем в центральной Г-долине. Это означает высокую вероятность междолинного перехода. Междолинный переход происходит с участием оптических и акустических фононов с большим волновым числом, соответствующим разнице волновых чисел между центральной и боковыми долинами.
Возможен и обратный переход из боковых в центральную долину. Электроны, совершившие такой переход (перешедшие в Г-долину), теряют в средней направленной скорости, т. е. их дрейфовая скорость в момент перехода в среднем стремится к нулю.
Этот эффект внешне очень похож на воздействие неупругого рассеяния на оптических фононах в Si. Наличие в Г-долине определенного количества электронов, которые претерпели обратный переброс, приводит к ускорению насыщения скорости при меньших энергиях, чем та, которая характерна для средней дрейфовой скорости электронов в Г-долине.
Теперь обратимся ко второму фактору увеличения рассеяния — «убеганию» электронов. Вообще говоря, это «не прямой» фактор. Он как бы облегчает условия возникновения междолинного рассеяния.
Обратим внимание на то, что в определенный момент приходится рассматривать время релаксации по энергии if, а не хр, как это было до сих пор. Из рис. 7.3, где по горизонтальной оси отложена разность между энергией электрона и начальной (тепловой) энергией, видно, что до определенного предела время релаксации по энергии растет с увеличением энергии. Это означает, что, несмотря на происходящие акты рассеяния и падение хр и У</</i> до определенного значения энергии (следовательно, и поля F), скорость приобретения электронами энергии от внешнего поля оказывается больше, чем скорость ее потерь. За один акт рассеяния не все электроны, даже встретившись с оптическим фононом, теряют всю накопленную от поля энергию.
До столкновения Е = ?0 + qFl. При столкновении электрон теряет (рассеивает) часть своей энергии ?рас < Е0 + qFl. Тогда после столкновения новая (стартовая) энергия электрона будет равна Е = Ео + А?, где АЕ = Е0 + qFl — Е^. Следовательно, стартовая позиция этого электрона перед следующим накоплением энергии от поля будет уже выше, чем Е0. Иными словами, для части электронов избыточная энергия из-за взаимодействия с полем начинает быстро расти, увеличивая дисбаланс между приобретением и рассеянием энергии в сторону приобретения. В результате при определенных значениях электрического поля скорость приобретения энергии от внешнего поля оказываегся больше, чем скорость ее потерь.
Таким образом, можно сказать, что электрон как бы «убегает» вперед по шкале энергий, пока не достигнет условий включения какого-либо механизма, сдерживающего этот рост энергии. Именно таким механизмом при энергиях электронов выше 0.3 эВ является междолинное рассеяние.
На рис. 7.5 показана зависимость частоты рассеивающих столкновений v в GaAs от энергии электрона. Эта величина часто используется для оценки относительной роли различных механизмов рассеяния в процессах переноса. Она представляет собой вероятность рассеяния электрона с волновым вектором к в единицу времени и имеет вид.
 aside class="viderzhka__img" itemscope itemtype="http://schema.org/ImageObject">
aside class="viderzhka__img" itemscope itemtype="http://schema.org/ImageObject">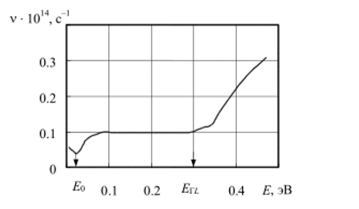
На рисунке хорошо видны скачок частоты соударений при энергиях, соответствующих энергии оптического фонона, и более мощный скачок частоты соударений при энергиях, соответствующих междолинному рассеянию.
Происходит очень интересное явление. Процесс «убегаРис. 7.5. Зависимость темпа рассея- пия» как бы поставляет ния от энергии электрона: Ео — энер- электроны, обладавшие из- гия оптического фонона, EVL — начально относительно ма- энергия^ минимума L-долины, Т = лой энергией, в область
энергий междолинного рассеяния. Это означает, что к количеству электронов, достигших энергии междолинного рассеяния, благодаря вероятностным процессам (не было рассеивающих столкновений) прибавляются электроны с изначально малой (относительно энергии междолинного переброса) энергией, т. е. получается, что электроны с малой энергией (относительно междолинного переброса) в результате эффекта убегания испытывают междолинное рассеяние. По этой причине насыщение дрейфовой скорости в Г-долине наступает не при скоростях, соответствующих междолинной энергии, а на порядок меньше.
Необходимо отметить, что «убегание» — это процесс, который зависит не только от напряженности, но и от времени действия поля. Поэтому он может при определенных условиях захватить электроны с очень низкой энергией, даже близкой к нулю. Но эффект, безусловно, критичен к величине поля, взаимодействующего с электроном.
Убегают электроны, попавшие в хвост функции распределения, где их энергия больше энергии убегания. Эффект убегания можно охарактеризовать средним временем убегания т^, которое, естественно, зависит от величины электрического поля. С его помощью можно подсчитать число электронов, убежавших в верхнюю долину из-за эффекта убегания [7],.

где /0 — время, за которое электрон приобретает энергию 0.3 эВ без рассеяния.
![Зависимость распределения горячих электронов в Lи Х-долинах зоны проводимости GaAs от электрического поля [3].](/img/s/8/19/1469219_14.png)
Рис. 7.6. Зависимость распределения горячих электронов в L- и Х-долинах зоны проводимости GaAs от электрического поля [3].
Отсюда видно, что наличие электронов с малой энергией, например, в канале транзистора увеличивает количество убегающих электронов, уменьшает дрейфовую скорость и, следовательно, ограничивает возможное быстродействие транзистора, если не принимать специальных мер.
Основная масса электронов, претерпевших переброс в верхние долины (опять же вследствие высокой плотности состояний в них), остается в этих долинах. Из рис. 7.6 видно, что с ростом электрического поля сначала заполняется L -долина, а затем X -долина. Междолинный переброс ведет к снижению средней дрейфовой скорости электронов, так как подвижность и дрейфовая скорость электронов верхних долин меньше, чем в Г-долине.
С учетом приведенного распределения можно оценить среднюю скорость электронов в канале транзистора при заданном значении электрического поля.

где Апг + AnL + Апх = п0 — сумма долевых вкладов электронов в разных долинах.
В результате иерезаселения долин в GaAs и некоторых других полупроводников дальнейший рост поля с определенного момента не увеличивает, а уменьшает дрейфовую скорость.
Проведенные на основании вышеизложенного расчеты показывают, что стационарная максимальная дрейфовая скорость в полупроводнике не может превышать (1−3)* 10 см/с при Г=300 К. Это, казалось бы, накладывает принципиальное ограничение на быстродействие приборов. Однако для корогких образцов в динамическом режиме можно получить дальнейшее увеличение дрейфовой скорости электронов.