Радиационная стойкость электронных приборов

Коэффициент диффузии: ?> — доза радиации; Ь = *[ГУх: Ь0 = Т^дЙфо^о • Второе выражение (23.3) следует из первого, если считать, что коэффициент диффузии не изменяется под действием радиации, т. е. /)диф = ?>диф0, что на практике достаточно хорошо выполняется. На рис. 23.22 приведены зависимости диффузионной длины Ь от дозы облучения электронами с энергией 1 МэВ для кремниевого солнечного элемента… Читать ещё >
Радиационная стойкость электронных приборов (реферат, курсовая, диплом, контрольная)
Основные сведения об ионизирующих излучениях. Под радиационной стойкостью понимается возможность электронных приборов работать под воздействием проникающего ионизирующего излучения (ИИ) при изменении основных параметров в пределах норм, регламентированных техническими условиями.
По физической природе ИИ подразделяются на следующие основные виды: а-и у-излученияг нейтронное (п), электронное (е), протонное (р) излучения.
Тяжелые частицы (ос-частицы и осколки деления ядер) из-за их малой проникающей способности оказывают незначительное влияние на изделия электронной техники. Источником а-частиц может быть естественная радиация элементов конструкции ИС. а-частицы испускаются незначительным количеством радиоактивных примесей, присутствующих в материалах конструкции ИС.
Источниками ИИ являются ядерные энергетические установки, ядерные взрывы, естественные и искусственные радиационные пояса Земли, космические лучи и др. Космические лучи образуются за счет галактического излучения и излучения Солнца. Галактические лучи представляют собой ядра различных химических элементов (— 85% протоны, ~ 15% ядра гелия и очень небольшая доля тяжелых элементов).
Искусственные радиационные пояса возникают в результате ядерных взрывов в верхних слоях атмосферы и имеют определенный период существования. Естественные радиационные пояса Земли образуются в результате захвата магнитным полем Земли потоков заряженных частиц, входящих в состав космических лучей. Эти пояса делятся на внутренний, расположенный на высоте 600…1500 км, и внешний радиационный пояс, расположенный на расстоянии ~ 1,5 радиуса Земли.
Основными характеристиками ИИ являются: энергия частиц, выражаемая в электрон вольтах (эВ); плотность потока частиц определяемая числом частиц, проходящих через единичную площадку в 1 см2 за 1 с; интегральный поток Ф, т. е. усредненный по всему энергетическому распределению частиц со сложным энергетическим спектром (Ф определяется плотностью потока частиц, умноженной на время облучения, част/см2); доза (поглощенная доза) Г) и мощность дозы (мощность поглощенной дозы) Р — для излучения со сложным энергетическим спектром (?) — это энергия, переданная веществу ионизирующим излучением в расчете на единицу массы; мощность дозы Р — значение дозы, отнесенное к единице времени). Доза излучения В измеряется в Дж/кг и рад (Дж/кг — 1 Гр -= 102 рад), а мощность дозы Р — в Вт/кг.
Для количественного описания рентгеновского и у-излучений с энергией квантов не выше 2 МэВ, ионизирующих вещество, используют такую характеристику, как экспозиционная доза Ву. Единица измерения 1>у— Кл/кг — это экспозиционная доза, при которой в результате ионизации в единице массы (1 кг) возникает такое количество заряженных частиц, которое переносит заряд каждого знака в один кулон. Широко применяется внесистемная единица, определяющая экспозиционную дозу, — рентген, равный 2,58 • 10-4 Кл/кг.
В зависимости от продолжительности воздействия на материалы различают импульсное и непрерывное ИИ. Импульсное ИИ реализуется в условиях ядерного взрыва, а непрерывное — при наличии ядерных энергетических установок, космических лучей и т. п. Для оценки импульсных ИИ вводят такой параметр, как экспозиционная доза мгновенного излучения, которая определяется соотношением лгмгн = р/' Кл/кг, где * — длительность импульса излучения; Ру— мощность дозы в импульсе мгновенного у-излучения, которая определяется в А/кг. Типичные значения t колеблются в пределах 10″ 7…Ю-3 с.
Как правило, эффекты, порождаемые импульсной радиацией, вызывают обратимые изменения электрических параметров изделий. Отметим некоторые характеристики наиболее мощных источников ионизирующих излучений. На расстоянии 1 км от центра ядерного взрыва интегральный поток нейтронов Ф ~ (3…5) • 1016 нейтр/см2. Излучение в активной зоне мощного реактора (~ 1000 МВт) характеризуется следующими величинами: плотность потока нейтронов N — 10й…1015 нейтрДсм2 • с);
мощность дозы уизлучения Ру ~ 103А/кг. При мощности реактора 100 кВт Ру ~ 10-1 А/кг, N ~ 1010 нейтр/(см2 • с). Частицы галактических лучей обладают очень высокой энергией (108…102° эВ), но плотность потока их очень мала. Доза облучения на летательном объекте за год составляет в этом случае ~ 10 2…10 1 Дж/кг (1…10 рад).
Максимально возможные годовые дозы для протонов солнечных космических лучей достигают величин порядка 10…102 Дж/кгЦО^.ЛО'1 рад) на поверхности аппарата и 1…10 Дж/кг (102…103 рад) за слоем защиты[1] 1 г/см2. Годовые экспозиционные дозы излучения на поверхности космического летательного аппарата от внутреннего и внешнего радиационных поясов Земли при облучении электронами с энергией 0,02…5 МэВ соответственно составляют 1012 и 10й… 1013 рад в год, а за слоем защиты 105 рад в год. Протоны внутреннего пояса дают экспозиционную дозу на поверхности аппарата 1010 рад в год, а за слоем защиты 105 рад в год. Излучение искусственных радиационных поясов характеризуется следующими величинами: ?) ~ 10® Гр (107рад), — 10 !…10 4А/кг.
Максимально возможная годовая доза облучения радиоэлектронной аппаратуры, обусловленная потоками электронов из искусственных радиационных поясов, может составлять на поверхности аппарата 10е… 107 Дж/кг (108…109 рад), а с учетом защиты аппаратуры корпусом летательного аппарата — 103…104 Дж/кг (105…108 рад). Таким образом, радиационная обстановка на борту околоземных космических объектов определяется в основном протонами внутреннего радиационного пояса и электронами искусственных радиационных поясов Земли.
Проблема обеспечения радиоэлектронной аппаратуры материалами и приборами, устойчивыми к воздействию проникающей радиации, является весьма сложной из-за большого числа используемых в них материалов. Уровень воздействия ИИ на радиоэлектронные изделия, в том числе на электронные приборы, зависит от комплекса физических, химических, технологических и конструктивных факторов.
Основные типы радиационных дефектов в твердых телах. В результате взаимодействия ядерных излучений с атомами твердого тела происходят следующие процессы: смещение атомов из устойчивых положений в решетке, ионизация, иногда появление в решетке примесей за счет ядерного деления, а также задержки в решетке (внедрения в нее) тех атомов, которыми производилось облучение.
Характер радиационных повреждений зависит от типа связей в облучаемом твердом теле, от вида и условий облучения.
Все дефекты, возникающие в кристаллической решетке твердого тела под действием ионизирующего излучения, разделяются на простые (точечные) и сложные (комплексы), представляющие совокупности простых.
Электрои теплопроводность, механические, оптические и магнитные свойства, коэффициенты диффузии свободных носителей и другие характеристики реальных кристаллов связаны с точечными дефектами.
Дефекты чаще всего проявляются в виде смещения атомов с образованием вакантных узлов и внедренных атомов. Существенное изменение электрофизических параметров твердого тела наблюдается при количествах радиационных дефектов и внедренных атомов, сравнимых с исходным числом дефектов и примесей, присущих исходному кристаллу.
Существует несколько теоретических моделей описания радиационных нарушений в твердом теле. Наиболее распространенные из них используют предположение об образовании первичных точечных дефектов в кристаллической решетке в результате упругого столкновения движущейся частицы с ядром для атомов вещества. При этом полагается, что атом смещается из своего нормального положения в решетке, если приобретенная им энергия Еп больше некоторой пороговой энергии Еи, которая зависит от энергии связи атомов в кристаллической решетке. В узле, где атом находился до столкновения, образуется вакансия. В твердых телах с сильными связями пороговая энергия имеет порядок величины Еа ~ 25 эВ.
Первичный смещенный атом, если он обладает достаточной энергией, перемещаясь по решетке, вызывает возбуждение, ионизацию и образование вторичных смещенных атомов. Потеряв запас энергии, он остановится в междуузлии. Таким образом, при Ел > Ел полное число смещений атомов превышает число актов их взаимодействия с ионизирующими частицами (ИИ) из-за развития каскадных процессов. Теория каскадного процесса образования сложных дефектов наряду со смещениями атомов в междуузлия учитывает их переход в другие узлы решетки за счет замещения атомов решетки движущимися атомами (частицами).
Процессы упругого смещения атомов определяются структурными особенностями твердого тела. В кристаллической решетке можно выделить направления с более плотной упаковкой атомов, где имеются условия для облегченной передачи энергии ИИ атомам. В этих направлениях при облучении кристалла образуются области уплотнения, а вдоль трека (направления движения) взаимодействующей частицы формируется область разрыхления (сложный дефект). В реальных кристаллах всегда существуют различного типа дислокации с поверхностной плотностью до 10к см-2. При облучении вещества наиболее вероятны размножения дислокаций, которые также относятся к сложным дефектам. Наличие химических примесей в кристаллах может привести к возможности взаимодействия с ними простых радиационных дефектов и образования стабильных комплексных дефектов. Большинство устойчивых радиационных дефектов в германии, кремнии, арсениде галлия и других материалах появляются в результате взаимодействия точечных дефектов между собой и с атомами примесей, имеющихся в веществе до облучения. Различные виды ИИ образуют дефекты, отличающиеся своими свойствами. Коротко рассмотрим воздействие на материалы каждого вида ИИ.
Быстрые нейтроны (кинетическая энергия > 100 кэВ), проникая в твердое тело, в основном образуют структурные радиационные дефекты в результате упругого взаимодействия с ядрами. При этом быстрый нейтрон передает ядру часть своей кинетической энергии, что может вызвать ионизацию атома. Энергетический спектр быстрых нейтронов ядерного реактора занимает диапазон 0,1…14МэВ при средней энергии.
1,5…2 МэВ.
При расчетах полного числа смещений обычно полагают, что все нейтроны обладают одной энергией, равной средней. Вклад нейтронов в диапазоне более 2 МэВ незначителен, и им пренебрегают. Из-за высокой проникающей способности быстрых нейтронов в веществах со средним атомным весом распределение дефектов по объему кристалла является равномерным.
Тепловые нейтроны (энергия 0,5 эВ и менее), имеющиеся в спектре реакторного излучения, хотя и приводят к ядерным превращениям, которые по своему действию подобны своеобразным легирующим примесям, вызывают меньшее число структурных дефектов по сравнению с быстрыми.
Протоны при взаимодействии с веществом теряют кинетическую энергию за счет упругих и неупругих столкновений с атомами. Упругое рассеяние преобладает при энергии протонов менее 50 МэВ. Если энергия протонов более 50 МэВ, то необходимо учитывать, как упругое, так и неупругое рассеяние.
Расчеты показывают, что протоны с энергией Еар =2,5 МэВ передают при однократном столкновении с атомами кремния и германия относительно небольшую энергию (Ея гр ~ 130 эВ) по сравнению с нейтронным облучением (Еа ср = 100 кэВ для и ?п гр = 40 кэВ для ве при энергии нейтронов Еп = 1,5 МэВ), что свидетельствует о возможности создания большого числа первично смещенных атомов при передаче быстрыми протонами небольших порций энергии атомам решетки. По сравнению с нейтронами, которые рассеиваются на ядрах, протоны рассеиваются в результате кулоновских взаимодействий как с электронными оболочками атомов, так и с ядрами, что приводит к формированию большого числа дефектов.
Электроны при взаимодействии с веществом чаще всего испытывают неупругое рассеяние, вызывающее ионизацию атомов. Однако наряду с этим определяющим процессом некоторую роль может играть упругое рассеяние, приводящее к смещению атомов в междуузлия. Сказанное о характере взаимодействия нейтронов и заряженных частиц с атомами и ядрами хорошо иллюстрируется данными, приведенными в табл. 23.1.
Таблица 23.1.
Зависимость числа первично смещенных атомов в 1 см;< вещества от вида и энергии нал учения (в расчете на одну быструю частицу).
Материал. | Нейтроны. | Протоны. | Электроны. | |
Еы = 2 МзВ. | ?"р-2МэВ. | ?пр = 5 МэВ. | Ее = 2 МэВ. | |
Кремний Еа = 12,9 эВ. | 2,8. | |||
Германий Еа = 14,5 эВ. | 1.2. | |||
Гамма-кванты (у-кванты) при прохождении через вещество вызывают в основном ионизацию атомов и смещение атомов при упругих столкновениях комптоновских электронов (см. ниже) с атомами материала.
ИИ при ядерных и термоядерных взрывах, от импульсных ускорителей и различных изотопных источников содержит у-кванты с кинетической энергией до 10 МэВ, для которых характерны три основных процесса взаимодействия с веществом; это фотоэлектрическое поглощение (фотоэффект), комптоновское рассеяние (Комптон-эффект) и эффект образования электронно-дырочных пар (соответственно области А, С и В на рис. 23.1). Каждый из упомянутых процессов проявляется при определенных значениях энергии у-квантов и атомного номера элемента Z (см.
рис. 23.1). В каждом из процессов возникают электроны с энергиями, сравнимыми с энергией падающих квантов. Следовательно, у-облучение сопровождается внутренней бомбардировкой вещества быстрыми электронами, что может также вызвать смещение атомов. Энергия комптоновских электронов зависит от энергии падающего у-кванта и атомного веса мишени.
При больших значениях мощности дозы у-излучения происходит сильная ионизация вещества и окружающей его газовой среды, что может вызывать значительное изменение электрофизических свойств облучаемого образца.
Влияние ионизирующих излучений на параметры полупроводников.
Характер дефектов кристаллической решетки полупроводниковых материалов, обусловленных воздействием радиации, не отличается от рассмотренных. Возникающие дефекты в объеме полупроводников приводят к изменению концентрации свободных носителей заряда л, их подвижности р, времени жизни т и диффузионной длины Ь.
Время жизни неосновных носителей заряда в объеме полупроводников чаще всего определяется не прямой рекомбинацией зона—зона,.

Рис. 23.1.
а через энергетические уровни ловушек, расположенные в запрещенной зоне. Возникновение радиационных дефектов приводит к формированию глубоких энергетических уровней в запрещенной зоне полупроводника, что увеличивает скорость объемной рекомбинации и, соответственно, уменьшает время жизни пар неравновесных носителей заряда. Несмотря на появление в запрещенной зоне полупроводника большого числа уровней, многие из которых являются рекомбинационными, время жизни в облученном материале, как показывают эксперименты, определяется лишь одним-двумя доминирующими рекомбинационными центрами. Если концентрация рекомбинационных центров достаточно мала по сравнению с концентрацией равновесных носителей заряда, то, как показывают теоретические расчеты, в случае одного доминирующего уровня время жизни носителей т обратно пропорционально концентрации рекомбинационных центров 7УГ, которая, в свою очередь, прямо пропорциональна интегральному потоку облучения. Следовательно, изменение обратного времени жизни носителей.

носителей заряда до и после облучения) при облучении пропорционально концентрации рекомбинационных центров Nг, или интегральной плотности потока ионизирующих частиц Ф:

где Кх — коэффициент радиационного изменения времени жизни неосновных носителей заряда, зависящий от концентрации основных носителей заряда, скорости образования радиационных центров и от степени заполнения их электронами.
Таким образом, при увеличении Ф время жизни уменьшается, а изменение обратного времени жизни Д | увеличивается, что проиллюстрировано в качестве примера для с удельным сопротивлением р — 100 Ом* см на рис. 23.2, где кривая 1 определяет влияние облучения на время жизни у-квантами, 2 — электронами с Ее = 2,5 МэВ, 3 — электронами с ?" = 30 МэВ, 4 — быстрыми нейтронами.
Анализ экспериментальных результатов исследования влияния радиации на подвижность носителей показывает, что наблюдаемые изменения подвижности обусловлены не только рассеянием на ионизованных атомах, возникших в результате облучения (падающие правые вет;

Рис. 23.2.
ви кривых 4у 5, 6 на рис. 23.3), но и на фононах, появляющихся из-за эффектов смещения атомов (левые нарастающие ветви кривых 4У 5, 6 и кривые 2У 3). Кривые 2 и 4 получены при облучении потоками нейтронов соответственно с интенсивностью Фн = 1,6 • 10м см~2 и Фн = 3,3 • 1015 см-2, кривая 3— электронами с Ф, = 1015см-2; 5, б— протонами с Фпр = = 1014 см 2 и Ф = 6 • Ю14 см 2 и энергией ?пр = 660 МэВ. Значительное уменьшение подвижности при низких температурах большие значения во время облучения по сравнению с исходным состоянием обусловлено появлением ионизованных атомов и комплексов атомов. Радиация увеличивает число заряженных неподвижных частиц, что приводит к возрастанию вероятности кулоновских столкновений свободных носителей с ионами и, соответственно, к уменьшению подвижности. Поскольку физические механизмы взаимодействия с веществом полупроводников потоков облучения различной природы количественно и качественно могут существенно различаться (см. табл. 23.1), изменение подвижности в для каждого типа потоков будет разное, что хорошо видно на примере рис. 23.4 (кривая 1 — у-кванты, 2 — электроны с энергией 10 МэВ, 3 — быстрые нейтроны).
Изменение концентрации свободных носителей в наиболее сильно сказывается при небольших уровнях легирования и облучении потоком нейтронов с Фн > 1014 нейтр/см2.
Радиационная стойкость полупроводниковых диодов. К настоящему времени наиболее изучены радиационные эффекты в выпрямительных диодах. В кремниевых диодах при воздействии ионизирующего излучения любого вида с достаточно высокой энергией происходит деградация его вентильных свойств, связанная с увеличением обратной и уменьшением прямой проводимости. Скорость деградации в основном определяется шириной базы IV, ее удельным сопротивлением рБ и значением прямого тока /пр. Помимо этого, заметное влияние оказывают энергия излучения, концентрация примесей в эмиттерной области, градиенты концентрации и время жизни дырок в базе хр (для базы с электронной проводимостью). В большинстве случаев в кремниевых диодах наибольшие изменения при облучении претерпевает прямая ветвь ВАХ, поэтому радиационную стойкость диодов часто оценивают по двукратному увеличению прямого напряжения ?/пр при заданном прямом токе /пр.
Основными электрофизическими параметрами полупроводников, определяющими изменение ВАХ при облучении, являются тру Мд, рБ и IV. Изменение времени жизни дырок хр в базе диода, которое является функцией упомянутых параметров Nд, рБ и IV, в широком диапазоне значений /пр при различных видах облучения можно оценить по формуле (23.1).

Рис. 23.3.
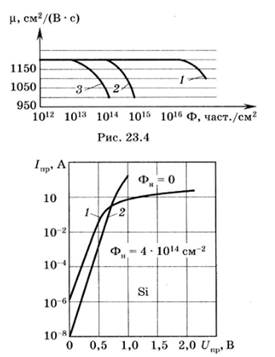
Рис. 23.5.
ВАХ в широком диапазоне значений прямых токов и изменение прямого напряжения (У|1р кремниевых диодов при облучении нейтронами представлены на рис. 23.5 и 23.6 соответственно. На рис. 23.5 кривая 1 получена при Фн = О, т. е. в отсутствие облучения, а кривая 2 — при Фн = 4 • 1014 нейтр/см2, на рис. 23.6 С/пр0 — прямое напряжение при Фи «0, и заштрихованные области — разброс значений ?/пр/?/Про Для различных примесей (например, В и А1). Диоды, где в качестве примеси использован бор (В), имеют большую радиационную стойкость, чем при использовании алюминия (А1).

Рис. 23.6.

Рис. 23.7.
Облучение диодов при повышенных температурах вызывает существенно меньшие изменения их свойств за счет частичного отжига радиационных дефектов. Отжиг — это ускоренное восстановление заряда внутри материала (см. далее воздействие ИИ на МДП транзисторы).
Влияние облучения на различные типы диодов иллюстрирует рис. 23.7, где кривые /, 2 получены при облучении различных марок выпрямительных диодов, а 3, 4 — импульсных; С/пр0 — прямое напряжение на диоде при Фн = 0.
Влияние радиации на обратные ветви ВАХ кремниевых диодов в основном определяется процессами, происходящими в р—л-переходе. Облучение изменяет эффективное распределение не скомпенсированной примеси вблизи р— п перехода, т. е. влияет на толщину перехода. Это связано с тем, что при облучении происходит изменение эффективной концентрации носителей в базовой области. Изменением же концентрации основных носителей в эмиттере можно пренебречь, так как для р*—л перехода /Уа (см. п. 2.1), поэтому увеличение толщины перехода при облучении происходит в основном в сторону базы.
Кроме того, наличие в переходе значительных градиентов концентрации легирующей примеси приводит к тому, что при облучении может наблюдаться существенное изменение градиентов концентрации свободных носителей и, следовательно, токов, текущих через переход. Зависимость плотности обратного тока от потока нейтронов для кремниевых диодов с р,. = 2,5 Ом • см при = 300 В представлена на рис. 23.8 (кривая 1 получена при Т — 18 °C, 2 — при Т = 100 °С). Изменение ширины перехода при облучении естественно будет вызывать и изменение барьерной емкости.
Германиевые диоды имеют очень низкую радиационную стойкость, т. е. при облучении в них резко возрастает обратный ток р, поскольку в отличие от диодов на основе кремния основной вклад в, вносит диффузионная, а не генерационная составляющая тока (см. табл. 23.1).
р—/—п-диоды. В отличие от диодов с низкоомной базой при описании радиационных эффектов в этих диодах вместо традиционных параметров используют только одну радиационную константу Кх (23.1). Расчеты и эксперименты показывают, что радиационная чувствительность.
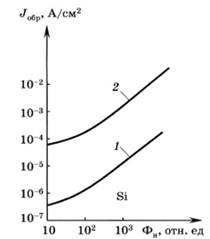
Рис. 23.8.
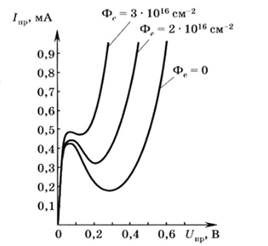
Рис. 23.9.
р—I—л диодов, определяемая коэффициентом КхУ прямо пропорциональна квадрату толщины базовой области.
Туннельные диоды. Радиационные эффекты в туннельных структурах сложны и разнообразны из-за того, что процессы переноса носителей могут происходить одновременно как непосредственно между зонами, так и с участием уровней в запрещенной зоне, образуемых за счет ИИ. Особенно сильно изменяется ток впадины /н (избыточный ток), который как раз и определяется туннелированием носителей на уровни в запрещенной зоне. Пиковый ток /п также заметно растет при облучении (рис. 23.9). Среди диодов различных типов туннельный является наиболее радиационно стойким.
В момент воздействия импульсного ИИ в р—л переходе диода образуются избыточные неосновные носители, которые под действием поля перехода разделяются, как при фотовольтаическом эффекте (см. п. 16.4). В результате во внешней цепи диода возникает импульс тока с амплитудой, пропорциональной площади перехода и мощности дозы излучения Ру т. е.

где Ьпу Ьр — диффузионные длины носителей; — ширина обедненной области перехода; — фактор ионизации (4,3 • 1013 см 3 • Гр 1 для кремния).
Наиболее критичными параметрами к импульсному ИИ у диодов являются обратный ток и прямое падение напряжения. Мощность дозы у излучения для диодов Ру = 105…106 Гр/с. При этом изменение С/пр обусловлено явлениями, подобными вентильному фотоэффекту, как в фотодиодах.
Радиационная стойкость транзисторов. При облучении большинство параметров биполярных транзисторов (БТ) изменяется. Однако, как правило, из всех параметров рассматривают один основной — статический коэффициент передачи тока. Изменение этого коэффициента, связанное с объемными и поверхностными явлениями, определяет радиационную стойкость большинства самых разнообразных схем, где используются БТ. Объемные изменения под действием ионизирующего излучения обусловлены в основном упругим рассеянием ИИ с образованием радиационных дефектов, приводящих к изменению времени жизни, концентрации и подвижности носителей заряда.
Неупругое рассеяние излучения ионизирует газ в корпусе прибора и генерирует свободные носители в веществе, которые захватываются поверхностными уровнями. В результате ионизации газа может происходить осаждение ионов на поверхность полупроводника. Как захват свободных носителей поверхностными ловушками, так и осаждение ионов изменяют поверхностные свойства полупроводника, в частности скорость поверхностной рекомбинации. При наличии объемных и поверхностных явлений в полупроводнике изменение статического коэффициента передачи тока в схеме с общим эмиттером (Л21Э) может быть оценено, но формуле.

где *ак — время пролета носителей между эмиттером и коллектором; АГзфф — эффективный коэффициент радиационных повреждений, связанный прежде всего с изменением времени жизни неосновных носителей заряда и скорости поверхностной рекомбинации, т. е. Кэ^ по сравнению с Кх учитывает большее число факторов, изменяющих время жизни в конкретных приборах. Например, Кэ^ в германиевых транзисторах определяется: радиационным изменением времени жизни неосновных носителей заряда в активной и пассивной областях базы; конфигурацией и геометрическими размерами как этих областей, так и эмиттера; величиной внутреннего поля в пассивной базе. Для уменьшения влияния пассивной базы на величину Л21Э при облучении необходимо обрабатывать приэмиттерную поверхность базы транзисторов ускоренными ионами, а германиевые планарные приборы необходимо изготавливать с тонкими эмиттером и пассивной областью базы.
Величина для кремниевых транзисторов определяется ради ационными процессами в активной базе и в области пространственного заряда эмиттерного перехода.
На рис. 23.10 представлены экспериментальные зависимости относительных значений коэффициента передачи тока кремниевых транзисторов малой и средней мощности в зависимости от величины интегрального потока нейтронного Фн, электронного Фг, протонного Фпр и.
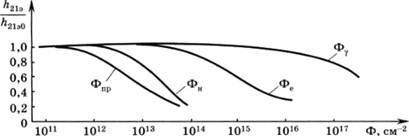
Рис. 23.10.
у-излучений Фу. Приведенные зависимости позволяют проводить ориентировочную оценку стойкости транзисторов к любому виду излучений.
В ряде приборов, таких, как германиевые непассивированные (с не протравленной поверхностью кристалла) транзисторы, кремниевые транзисторы, работающие в микрорежимах, МДП-транзисторы, в основном именно поверхностные изменения при облучении определяют радиационную стойкость приборов и стабильность их параметров после облучения. Основные процессы на поверхности полупроводников при облучении можно классифицировать следующим образом:
- — образование новых быстрых поверхностных состояний, что увеличивает скорость поверхностной рекомбинации;
- — возбуждение поверхностных состояний или захват генерируемых облучением носителей ловушками, что изменяет заряд поверхностных состояний и величину поверхностного потенциала;
- — ионизация газа в корпусе прибора при облучении и осаждение заряженных ионов на поверхности кристалла, что изменяет также поверхностный потенциал.
Для современных полупроводниковых приборов с пассивированной поверхностью, например, для планарных транзисторов с пленкой 8Ю2, ионизация газа в корпусе при облучении практически не сказывается на изменении их параметров.
Под действием ионизирующего излучения в пленке вЮ2 формируется дополнительный положительный заряд, что в совокупности с ростом плотности быстрых поверхностных состояний приводит к изменению параметров приборов. Так, в МОП-транзисторах с р каналом образование дополнительного положительного заряда смещает пороговое напряжение затвор—исток С/зи пор в сторону больших отрицательных значений, а увеличение плотности быстрых поверхностных состояний изменяет крутизну вольт-амперных и вольт-фарадных характеристик. Оба эти эффекта не исчезают после снятия ИИ.
Возникновение положительного заряда ионов можно объяснить следующим образом. Ионизирующее излучение вызывает образование электронно-дырочных пар в слое диэлектрика. Если к затвору приложено по;
ложительное относительно подложки напряжение, то, в первую очередь, из-за большой подвижности, электроны будут вытягиваться полем затвора. Дырки захватываются дырочными ловушками или рекомбинируют с электронами до выхода из окисла. В результате в диэлектрике 8Ю2 формируется избыточный положительный заряд. Образующийся заряд ф при фиксированном потенциале затвора уменьшает напряженность поля в окисле, что приводит к насыщению при росте поглощенной дозы й. Объемный заряд расположен внутри окисла на расстоянии нескольких десятков нанометров от границы раздела кремний—диэлектрик. Величина объемного заряда определяется только поглощенной дозой облучения. Величина и локализация пространственного заряда определяется величиной и полярностью напряжения смещения на затворе в процессе облучения. При этом наблюдается линейная зависимость наведенного заряда от напряжения затвор—исток С/зи. Это связано с тем, что все приложенное к затвору напряжение падает на слой объемного заряда, создающегося в окисле во время облучения, а не на весь слой окисла.
Положительный пространственный заряд в слое диэлектрика модулирует проводимость канала полевого транзистора и изменяет все его характеристики.
Наиболее чувствительны к облучению ИИ п канальные МОП-транзисторы, у которых наименьшие значения С/ЗИпор. Зависимость 1/ЗИпор для р канального транзистора от О дана на рис. 23.11. При увеличении *зи пор соответственно возрастает и время задержки *эд вкл сигнала при работе транзистора в импульсном режиме (см. рис. 23.11).
Облученные электронами образцы были стабильны при комнатной температуре в различных средах и при разных электрических режимах. Восстановление заряда до величины ?? ~ 10-11 см-2 протекает в течение нескольких месяцев. Процесс ускоренного восстановления пространственного заряда в окисле, который называется отжигом, происходит за счет нейтрализации его электронами, введенными в окисел. Обычно нейтрализующие электроны получают за счет или повышения температуры прибора (материала) — термического отжига, или облучения светом — УФ отжига. Восстановление заряда при термическом отжиге обусловлено инжекцией электронов из кремния в окисел. Одновременно при температурах отжига (150. .300 °С) происходит восстановление скорости поверхностной рекомбинации. УФ освещение вызывает заброс электронов в окисел из кремния. Этот процесс происходит с наибольшей интенсивностью при энергии кванта света Лу > 5 эВ, а начинается он при Лу — 3…5 эВ.
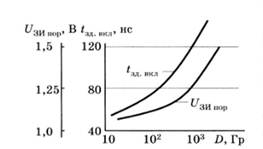
Рис. 23.11.
В настоящее время ведутся поиски новых диэлектриков для затвора, в которых скорости накопления заряда при облучении были бы минимальны. К таким диэлектрикам относятся структуры вЮ2—813Ы4 (нитрид кремния), а также А12Оэ. Одной из причин уменьшения скорости накопления заряда в этих диэлектриках при облучении ИИ является более высокая, чем у 8Ю2, проводимость, что приводит к частичной компенсации положительного объемного заряда дырок электронами проводимости.
Радиационная стойкость транзисторов к непрерывному ИИ в существенной мере зависит от их частотных свойств, технологии изготовления, конструкции. Для биполярных мощных НЧ-транзисторов предельные плотности потоков частиц (нейтронов) составляют Фн = = 3 • 10п…З • 1018 см~2, для ВЧ-транзисторов — Фн = 5 • 10, 5…5 • 1017 см 2, для МОП-транзисторов — Фн = 3 • 1012…2 • 10м см 2.
Наиболее критичными параметрами к импульсному ИИ являются токи через обратносмещенные переходы. Радиационная стойкость к импульсному ИИ составляет 103…106 Гр/с для кремниевых биполярных транзисторов. В схеме с общим эмиттером (ОЭ) из-за ИИ первичный ток коллекторного р—л перехода может вызвать вторичный ток эмиттерного перехода. Первичный ток, вызванный ИИ, является результатом диффузии неосновных носителей из коллектора в базу транзистора. В базе эти носители становятся основными и при малых токах утечки начинают снижать потенциальный барьер эмиттерного перехода. Для схемы транзистора с ОЭ этот эффект накопления носителей в базе приводит к открыванию транзистора и усилению коллекторного тока.
Для тиристоров импульсные токи, возникающие под действием импульсного ИИ, могут вызвать его переключение из закрытого в открытое состояние.
Следует также обратить внимание на возможность ионизации газа в герметичном корпусе транзистора, что может приводить к изменениям параметров транзисторов.
Радиационные эффекты в арсенид-галлиевых полупроводниковых приборах и интегральных схемах. Высокая подвижность свободных носителей (ц — 5000 см/(В • с)), большая ширина запрещенной зоны (Д?;| = 1,43 эВ), малые времена жизни носителей (т — 10 8 с) арсенида галлия делают этот материал одним из наиболее перспективных полупроводников для изготовления приборов и интегральных схем, работающих при повышенных температурах, в широком диапазоне частот, включая миллиметровый диапазон.
Основными причинами изменения характеристик ОаАв при воздействии ИИ, так же как у ве и 81, являются процессы возникновения радиационных дефектов в кристаллической структуре и генерации неравновесных носителей заряда.
Сравнительный анализ радиационного изменения электрофизических параметров арсенида галлия и кремния показывает, что с точки зрения влияния объемных эффектов смещения СаАв не имеет преимуществ перед в широком диапазоне концентрации легирующей примеси. Арсенид галлия отличает от кремния существенно меньшее время жизни носителей заряда, которое в значительной мере определяется процессами излучательной и ожерекомбинации, особенно при повышенной концентрации неравновесных носителей. В арсениде галлия указанные процессы по сравнению с кремнием более вероятны. Наряду с объемными эффектами смещения, на характеристики ОаАв-приборов могут существенно влиять изменение плотности поверхностных состояний и накопление заряда на границе раздела между областями прибора.
Рассмотрим остаточные эффекты в ОвАв-приборах. В настоящее время наибольшее применение в микросхемах на арсениде галлия находят диоды с барьером Шоттки (выпрямляющий контакт металл—полупроводник) и полевые транзисторы с длиной затвора от единиц до десятых долей мкм. Эти приборы используются в СВЧ-устройствах и сверхбыстродействующих логических элементах и ячейках памяти, являющихся основой цифровых интегральных микросхем (ИМС).
Диоды с барьером Шоттки имеют высокую граничную частоту, малое время переключения *11ер и ВАХ, близкую к идеальной. Коэффициент не идеальности (см. гл. 2) для СаАэ-диода равен т = 1,01…1,1, а для кремниевого р—я-перехода т = 1,5. Предельно достигнутые значения времени переключения <1|ср составляют единицы пс.
Детальное исследование радиационного изменения характеристик диодов Шоттки (ДШ) на основе контактов Аи-я ОаАэ и А1-я ваАв при облучении быстрыми нейтронами (рис. 23.12) позволило выявить доминирующие механизмы деградации этих приборов. ДШ были выполнены на основе эпитаксиальной пленки я СаАвс концентрацией легирующих.
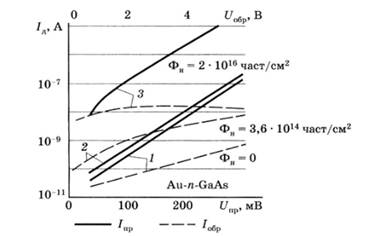
Рис. 23.12.
примесей 1015…1017 см-3. Значения потока нейтронов выбирались из условий малого изменения концентрации основных носителей. Причина увеличения обратного тока, а соответственно и прямого (рис. 23.13), в ДШ при облучении потоками нейтронов связана с увеличением туннельного тока, обусловленного переходами носителей из металла на радиационные уровни в запрещенной зоне обедненного слоя ДШ.
Ионное легирование базы (ионная имплантация) ДШ очень сильно изменяет радиационные характеристики приборов. Так, например, при облучении потоком нейтронов Фн = 3 • 1015 нейтр/см2 базы диода (контакт никель—п—ОаАв), легированной ионами бора (концентрация 1013см_3), увеличивается коэффициент неидеальности ВАХ для прямого напряжения С/пр = 0,2…0,3 В с т = 1,01 (Фн = 0) до т «4,25, а при ?/пр > 0,6 В — до т ~ 2. Столь сильное изменение т может быть обусловлено следующими физическими механизмами: туннелированием носителей через уровни ловушек в запрещенной зоне полупроводника, изменением высоты потенциального барьера, уменьшением концентрации свободных носителей, процессами генерации—рекомбинации в обедненном слое перехода.
Перейдем к рассмотрению остаточных эффектов при ИИ полевых гранзисторов с коротким каналом, длина которого обычно 0,5…2 мкм. В этих транзисторах реализуются высокие значения электрического поля в активной области канала и наблюдается насыщение скорости дрейфа электронов под затвором транзистора. В результате начало и наклон пологого участка выходных ВАХ при росте напряжения сток—исток определяются не только перекрытием канала, но и насыщением дрейфовой скорости. На рис. 23.14 (взят из [27]) показано влияние облучения полевых тран;

Рис. 23.13.

Рис. 23.14.
зисторов нейтронами и протонами на изменение крутизны 8 (кривые /), максимального тока стока /Смякс (кривые 2) и напряжения отсечки и^ (кривые 3). Как видно из рисунка, наиболее существенная деградация характеристик полевых транзисторов наблюдается при протонном облучении. Если в канале транзистора происходит насыщение скорости дрейфа носителей уд|) = иЩ) нас, то влияние радиации на указанные параметры заметно меньше, чем при идр < цдр няс. Это объясняется тем, что при идр = удр ннс скорость дрейфа определяется в первую очередь процессами взаимодействия носителей с кристаллической решеткой и в меньшей степени изменением концентрации, процессами рассеяния на объемных дефектах смещения. К наиболее важным характеристикам ПТ относятся коэффициенты усиления Ку и шума Кш. Повышенное изменение Ку и Кш при малых токах стока для напряжений затвора С/3 — Г/отс объясняется существенным уменьшением крутизны характеристики прибора с ростом потока нейтронов.
Радиационная стойкость кремниевых интегральных схем. При анализе радиационной стойкости изделий электронной техники все эффекты разделяются на остаточные (долговременные), связанные со структурными дефектами, и перемежающиеся, или переходные (кратковременные), обусловленные неравновесными носителями заряда.
Остаточные эффекты возникают, как правило, при воздействии непрерывного ИИ и могут быть обусловлены сложными дефектами кристаллической решетки, вызванными смещением атомов, появлением объемных зарядов при переносе носителей, а также локализованными неподвижными зарядами.
Переходные (кратковременные) эффекты существуют при воздействии импульсного ИИ и в течение относительно короткого времени после его прекращения и сопровождаются возникновением переходных процессов в схемах. Это проявляется в возникновении фототока, модуляции проводимости в полупроводниках, появлении элементарных дефектов, увеличении токов утечки. Интенсивность переходных эффектов может зависеть как от мощности дозы, так и от поглощенной дозы, а остаточные эффекты определяются в основном величиной поглощенной дозы ИИ.
Как известно, интегральные схемы (ИС) делятся на два класса: цифровые (логические, триггерные и т. д.) и аналоговые (многокаскадные усилители, стабилизаторы, преобразователи частоты и т. д.). В основе цифровых схем лежат простейшие транзисторные ключи (см. гл. 9), а в основе аналоговых (гл. 8) — простейшие усилительные каскады. Аналоговые ИС более чувствительны к ИИ, но сравнению с цифровыми, что можно пояснить, используя передаточные характеристики (рис. 23.15). В транзисторном ключе, являющемся основой цифровых ИС, замкнутое состояние (точка В) характеризуется малым падением напряжения, а ра зомкнутое (точка А) — большим падением напряжения на нем. Форма (вид) передаточной характеристики между точками А и В не играет заметной роли. Различные воздействия (температурные, радиационные, световые, электромагнитные и т. д.) изменяют передаточную характеристику в соответствии с пунктирными кривыми.
Небольшие колебания около точки В из-за радиации практически не меняют значения выходного сигнала, а значит, не влияют на работу ключа. В усилительном каскаде (аналоговая ИС) используется также и участок между точками А и В. Любая «деформация» характеристики будет непосредственно отражаться на работе схемы. Отсюда видно, что аналоговые схемы более чувствительны к различного рода воздействиям, в том числе и радиационным, по сравнению с цифровыми. В литературе очень мало сведений о радиационной стойкости аналоговых интегральных микросхем, поэтому в дальнейшем рассматриваются только цифровые микросхемы.
Интегральная микросхема, в отличие от дискретных приборов, является более сложным неоднородным устройством, включающим самые различные материалы — металлы, диэлектрики, полупроводники. На основе данных по воздействию ИИ на перечисленные материалы (см. п. 23.1, 23.2), а также на дискретные электронные приборы можно ожидать при исследовании радиационной стойкости элементов микросхем следующих результатов:
- 1) изменения концентрации и подвижности носителей заряда при воздействии облучения, особенно в полупроводниковых слоях с низкой степенью легирования;
- 2) резкого увеличения сквозных токов через диэлектрик из-за возникновения дефектных локальных состояний и накопления объемных зарядов ионов в диэлектрических слоях;
- 3) из-за возникновения центров рекомбинации и захвата как в объеме, так и на поверхности переходных областей металл—диэлектрик, металл—полупроводник, полупроводник—диэлектрик и р—я-переходов будут сильно изменяться свойства этих областей, в частности, возникать локальные поверхностные состояния, деформироваться профили распределения доноров и акцепторов и появляться внутренние электрические поля;
- 4) уменьшения времени жизни неосновных носителей.
Все эти эффекты будут в основном проявляться во всех элементах ИС. Стойкость микросхем хуже, чем транзисторов, из-за меньших размеров элементов и большого их числа, наличия изолирующих диэлектрических слоев, более сильного влияния поверхностных эффектов, их сложности и ряда других факторов конструктивно-технологического.

Рис. 23.15.
плана. При этом физические эффекты, возникающие при облучении полупроводниковых устройств, можно разделить на объемные и поверхностные.
До этого рассматривались объемные эффекты. Остановимся кратко на поверхностных и ионизационных эффектах. Поверхностные эффекты изменяют величину поверхностного потенциала и увеличивают скорость поверхностной рекомбинации. Появление же ионизационных токов связано с генерацией неравновесных электронно-дырочных пар. При воздействии импульсов ИИ большой мощности указанные эффекты могут вызвать закорачивание некоторых типов ИС, т. е. переход их в режим работы, подобный режиму работы открытого динистора. Такое явление часто называют эффектом •защелкивания" . В этом случае схема перестает функционировать до тех пор, пока не будет снято напряжение питания. Обычным типом отказа ИС при «защелкивании* являются короткие замыкания, вызывающие перегорание шины питания и выход схемы из строя. Режим «защелкивания* чаще всего наблюдается в КМОП и ТТЛ ИС (см. гл. 8, 9) с изолирующими р—п переходами; БИС КМОП (см. гл. 7—9) переходят в этот режим при меньших мощностях дозы, чем БИС ТТЛ.
В бортовой космической аппаратуре источниками ложных однократных срабатываний могут являться заряженные частицы высокой энергии (чаще всего протоны), которые, проходя через некоторую область микросхемы, формируют электрический сигнал, изменяющий логическое состояние цифровой схемы.
Многие параметры биполярных ИС функционально зависимы от коэффициента передачи тока транзисторов в схеме с ОЭ Л21э* поэтому деградация этого коэффициента определяет радиационную стойкость. Изменение напряжения насыщения С/кЭнас транзисторов ИС при облучении также связано с изменениями других параметров. Таким образом, Л21Э и ?/КЭнас являются теми параметрами, в которых интегрально проявляется воздействие ионизирующих излучений, поэтому радиационную стойкость биполярных ИС часто оценивают с помощью этих параметров. Для оценки влияния облучения на МДП ИС используют величины изменений пороговых напряжений (/пор, крутизны, коэффициента усиления, емкостей Сзи и Сзп, напряжения отсечки ?7^, максимального тока стока и ряд других.
Радиационная стойкость любого типа ИС зависит от схемотехнических, конструктивных и технологических факторов.
Радиационная стойкость цифровых МДП-интегральных микросхем.
Суммарная доза ионизирующего излучения более резко сказывается на МДП ИС, чем на биполярных. Она приводит к стабильному изменению порогового напряжения затвора ?/пор. Это связано главным образом с образованием поверхностных состояний на границе кремний—диэлект;
рик и накоплением положительных зарядов в подзатворном оксидном диэлектрике, захватываемых ловушками. Плотность поверхностных состояний резко возрастает при уровне накопленной дозы выше 106рад. Все это изменяет крутизну МДП-транзисторов, сдвигает I/ как л-, так и р канальных транзисторов, приводя в конечном счете к отказу схемы. КМДП ИС на кремниевых монолитных подложках более чувствительны к импульсному ионизирующему излучению, чем КМПД ИС на изолирующих подложках (примерно на два порядка). Это объясняется тем, что в МДП ИС вероятность возникновения радиационных дефектов и образования пар носителей в подложке и р—л-переходах, которые имеют больший объем, заметно больше, чем в КМДП ИС.
В современных БИС и СБИС используют транзисторы с характерными размерами областей порядка мкм и менее. Исследования влияния облучения на микросхемы показывают, что по мере уменьшения длины канала МДП-транзисторов влияние у-излучения на изменение порогового напряжения возрастает (рис. 23.16). В приборах с коротким каналом наблюдается повышенная степень загрязнения окисла после проведения сток-истоковой диффузии, что приводит к увеличенному числу дефектов и поверхностных ловушек.
КМДП БИС, сформированные на изолирующей сапфировой подложке, обладают лучшими характеристиками по сравнению с микросхемами на полупроводниковой подложке. Практическое применение таких ИС выявило ряд проблем, связанных с их радиационной стойкостью и не характерных для КМДП-схем на полупроводниковой подложке. Одной из причин, снижающих радиационную стойкость таких ИС, является образование положительного заряда в изолирующей сапфировой подложке во время облучения, что вызывает инверсию проводимости эпитаксиального слоя кремния, в котором формируются области транзисторной структуры. В результате токи утечки КМДП-структур на сапфировой подложке при воздействии ионизирующего излучения выше, чем в схемах на полупроводниковой подложке. Накопление во время облучения положительного заряда в окисле приводит к смещению ?/п пор в сторону больших по модулю отрицательных значений для р канальных и.
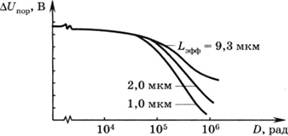
Рис. 23.16.
меньших значений для л-канальных транзисторов. Однако при суммарной дозе радиации, превышающей 10брад, пороговое напряжение для л канальных транзисторов начинает возрастать, что объясняется образованием на границе в1—8Ю2 поверхностных состояний, которые компенсируют положительный заряд окисла. КМДП-схемы высокой интеграции на полупроводниковой и сапфировой подложках обладают примерно одинаковой радиационной стойкостью, первые выдерживают дозу 103…105 рад, а вторые — 103…106 рад. Возможности схем на сапфировой подложке еще не полностью исчерпаны.
В настоящее время наиболее изучены радиационные процессы в динамических и статических запоминающих устройствах (ЗУ), поэтому рассмотрим поведение этих схем при облучении.
Основным элементом МДП ЗУ является ячейка памяти. Распределенная емкость С элемента запоминающей ячейки (показана штрихами на рис. 23.17) в динамическом ЗУ хранит информацию (см. гл. 9). При прохождении ионизирующей заряженной частицы /, например, а-частицы (а-частицы — двукратно заряженные ядра гелия, испускаемые элементами конструкции ИС), через области интегральной схемы, где существует электрическое поле, происходит разделение образовавшихся электронно-дырочных пар и накопление или электронов, или дырок в отдельных областях. Если траектория а-частицы проходит через обедненный слой ^ канального УМОП-транзистора (транзистора с К образными канавками), то образовавшиеся электроны будут накапливаться под действием поля затвора в ячейке (рис. 23.18), а дырки — инжектироваться в подложку.
Носители заряда, образовавшиеся в подложке вне зоны обеднения, диффундируют через нее. При этом они либо исчезнут за счет рекомбинации, либо, достигнув обедненной области, будут разделены полем, т. е. электроны втянутся в обедненную область, а дырки останутся в подложке. В результате такого разделения зарядов и собирания электронов в ячейке памяти может произойти переключение ее из состояния «единицы* в состояние «ноль*. Является ли заряд, генерированный а-частицами, достаточным для переключения ячейки, зависит от величины полного заряда, хранящегося в ячейке, энергии а-частицы, эффективности собирания заряда и т. д.
В рассмотренном случае только состояние логической единицы чувствительно к а-излучению, а состояние логического нуля нечувствительно. Генерированные а-излучением заряды могут распределиться по нескольким ячейкам, если расстояние между ними меньше диффузионной длины. В этом случае чувствительными к наведенному заряду могут ока;

Рис. 23.17.
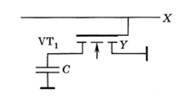
Рис. 23.18.
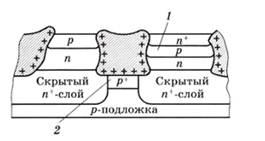
Рис. 23.19.
заться другие элементы схемы, что может привести к потере как «ноля», так и «единицы*.
Помимо перемежающихся (временных) отказов (сбоев) при больших дозах облучения в ИС возникают и необратимые повреждения. Необратимые повреждения в МДП ИС, обусловленные как у-излучением, так и действием токов быстрых частиц, имеют по сути дела одну и ту же природу. Различие состоит в том, что у-излучение приводит к отказу практически всех активных элементов ИС, а быстрые частицы вызывают отказы только отдельных приборов.
Влияние радиации на кремниевые интегральные схемы на биполярных транзисторах. Одной из основных отличительных черт активных элементов БИС, изготовленных по биполярной технологии, является повышенная стойкость их параметров к поглощаемой дозе ионизирующего излучения по сравнению с МДП ИС (особенно ИС с диэлектрической изоляцией элементов). Уровень устойчивости таких биполярных ИС к дозовым эффектам определяется параметрами окисла и границы Б1—БЮ2. На рис. 23.19 дана изопланарная структура транзистора, являющаяся одной из наиболее распространенных (на рис. 23.19: 1 — индуцированный канал между эмиттером и коллектором, 2 — канал между скрытыми слоями). Захват дырок в окисле на границе —вЮ2 и генерация поверхностных состояний при облучении приводит к образованию канала между скрытыми п'-слоями из-за инверсии слоя под дном диэлектрической изоляции и канала между эмиттером и коллектором п — р—п-транзистора (за счет инверсии области р базы вдоль боковой стенки диэлектрической изоляции). Помимо этого, увеличиваются токи рекомбинации у боковой стенки диэлектрической изоляции в области рбазы. Это обусловлено возрастанием скорости поверхностной рекомбинации за счет образования быстрых поверхностных состояний на границе —БКХ,. В результате этих процессов изменяется коэффициент передачи тока.
Инверсия типа проводимости р-области базы в результате индуцирования положительного заряда в слое окисла (см. рис. 23.19, область 2) и изменение плотности поверхностных состояний вызывают рост токов утечки между коллектором и эмиттером транзисторной структуры. Ире;
имущественное проявление влияния канала между скрытыми областями или канала между эмиттером и коллектором п—р—л-транзистора МС зависит от концентраций примесей области, предотвращающей образование канала под дном изолирующего окисла (р+-область), и области базы около боковой стенки. Чем выше уровень легирования р* -области, тем меньше утечка между скрытыми слоями.
В МС с изоляцией транзисторных структур за счет р—п-переходов основным эффектом, возникающим в результате импульсной радиации, является генерация фототока в многочисленных изолирующих переходах. Значение фототока пропорционально площади перехода, поэтому основными источниками являются изолирующие переходы большого размера. Эти паразитные токи обусловливают связь между различными элементами и изменяют характеристики активных элементов микросхемы, что приводит к изменению ее параметров. В частности, ионизационные токи изменяют (уменьшают) нормальный и инверсный коэффициенты передачи тока и." и а, транзистора, а в режиме насыщения соответственно и напряжение икинас ~ С/вых, которое возрастает.
В качестве примера такого влияния на рис. 23.20 показано изменение передаточной характеристики ИС ДТЛ (диодно-транзисторная логика) под действием быстрых нейтронов с энергией Е > 2,9 МэВ.
Указанные изменения связаны с уменьшением коэффициента пере;

Рис. 23.20.
дачи тока в схеме с ОЭ.

в зависимости от интенсивности радиационного облучения (рис. 23.21).
Радиационная стойкость оптоэлектронных приборов. Проблема радиационной стойкости достаточно остра для солнечных элементов, используемых на борту космических летательных аппаратов. Под влиянием облучения частицами высоких энергий мощность солнечных элементов понижается из-за образования дефектов в полупроводниках и изменения свойств других материалов, входящих в конструкцию данных приборов.
Продолжительность периода работоспособности бортовых солнечных батарей оценивается временем, в течение которого мощность солнечных батарей не выходит за пределы минимума, необходимого для функционирования основной аппаратуры летательного аппарата.
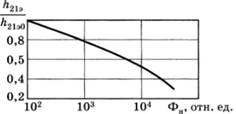
Рис. 23.21.
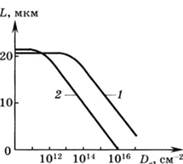
Рис. 23.22.
Возникновение дополнительных дефектов в полупроводнике под воздействием ионизирующего облучения приводит к уменьшению времени жизни частиц т и, соответственно, диффузионной длины Ь (поскольку ь = ЛЯ, см. п. 1.4) по закону.

где т0, Ь0 — соответственно время жизни и диффузионная длина до облучения; К' — коэффициент пропорциональности; К = К*/ИДИф; Лдиф —.
коэффициент диффузии: ?> — доза радиации; Ь = *[ГУх: Ь0 = Т^дЙфо^о • Второе выражение (23.3) следует из первого, если считать, что коэффициент диффузии не изменяется под действием радиации, т. е. /)диф = ?>диф0, что на практике достаточно хорошо выполняется. На рис. 23.22 приведены зависимости диффузионной длины Ь от дозы облучения электронами с энергией 1 МэВ для кремниевого солнечного элемента с р-базой (кривая /) и л-базой (кривая 2). Из рисунка видно, что радиационная стойкость элементов с р-базой существенно выше, чем элементов с л базой, что объясняется разной подвижностью и, соответственно, различными временами жизни электронов и дырок, а это, в свою очередь, определяет и диффузионную длину. Для повышения радиационной стойкости кремниевых солнечных элементов в них вводят литий, который нейтрализует дефекты и способствует стабилизации времени жизни при воздействии ИИ. Для защиты от ИИ перед лицевой поверхностью элемента делается тонкое прозрачное защитное покрытие, содержащее, например, церий. Для солнечных батарей предельные значения Фн = 10п.Л013см-2, ?>у= 10:*…104 Гр.
Воздействие облучения на фотоприемники сопровождается снижением коэффициента усиления, обусловленным эффектами, аналогичными тем, которые наблюдаются в диодах, транзисторах, солнечных элементах и других обычных полупроводниковых приборах.
Возникновение в полупроводнике при облучении уровней, формирующих центры безызлучательной рекомбинации, приводит к уменьшению мощности излучения светодиодов. Использование материалов с малыми временами жизни повышает радиационную стойкость этих приборов.
Радиационная стойкость оптронов. Изменение характеристик фотоприемников и светоизлучатолей под действием ИИ уменьшает коэффициент передачи и ухудшает импульсные свойства оптронов. Допустимые потоки нейтронов Фн для современных оптопар составляют 10, 2…Ю14 см-2, а дозы у-излучения 1)у = 105 Гр; при таких облучениях время задержки в оптопаре увеличивается в 2…3 раза, а потери интенсивности света в оптическом канале из-за изменения коэффициента пропускания возрастают на 10…20 дБ.
Радиационная стойкость электровакуумных приборов. Изменение характеристик этих приборов при облучении определяется в первую очередь ухудшением эмиссионных свойств катодов из-за деградации структуры поверхности, что вызывает изменение тока анода и крутизны характеристики.
Под воздействием ИИ может произойти растрескивание стекла, выделение электродами и конструкционными материалами газов, что нарушает вакуум внутри приборов. В результате этого снижаются предельно допустимые напряжения между электродами и ухудшаются другие характеристики. Импульсное ИИ вызывает в электровакуумных лампах увеличение токов утечки между электродами. Предельно допустимые дозы при этом составляют 105…107 Гр. Приемно-усилительные лампы в стеклянном баллоне выдерживают Фн = 1014…1015 см-2 и Оу = 105…108 Гр, в металлокерамическом корпусе — Фн = 1018 см 2.
Уровень радиационной стойкости изделий электронной техники зависит от конструкции, типа приборов, применяемых в них материалов и технологии их изготовления. Сравнение радиационной стойкости различных электронных приборов и ИМС позволяет произвести рис. 23.23, где введены следующие обозначения:
Д — диоды; ЭВП — электровакуумные приборы; р—/—я-диоды; МБПТ — мощные биполярные транзисторы; ПТ — полевые транзисторы; МДПТ — МДП-транзисторы; ТД — туннельные диоды; ВЧТ — высокочастотные транзисторы; СБ — солнечные батареи; ИСДИ — интегральные схемы с диэлектрической изоляцией; МК — магнитные ком;
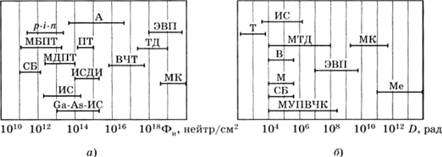
Рис. 23.23.
поненты; ИС — интегральные схемы; СаАй-ИС — арсенид-галлиевые ИС; Т — транзисторы; МТД — мощные ТД; В — варисторы; Ме — металл; МУПВЧК — мощные униполярные полевые ВЧ-ключи.
- [1] Слой защиты 5 в 1 г/см2 определяется как произведение плотности вещества с/ (г/см3) на толщину слоя I (см), например для железа I — Ъ/(1 — 1/7,8 ~ = 0,125 см.