КНИ-транзисторы.
Наноэлектроника

Полевые транзисторы (Field Effect Transistor), или FET-транзисторы, характеризуются максимальной удельной крутизной ВАХ, а также предельной частотой. При уменьшении длины канала и снижении сопротивлений пассивных областей стока R. и истока RH эти параметры улучшаются. Предельные значения gmax и /, пропорциональны предельной дрейфовой скорости Едр и подвижности носителей в канале. Подвижность… Читать ещё >
КНИ-транзисторы. Наноэлектроника (реферат, курсовая, диплом, контрольная)
Разработки транзисторных структур для субмикронной технологии следующих поколений на 0,13, 0,10, 0,07 мкм ведутся по разным направлениям. МОП-транзисторы, изготовленные по технологии «кремний на изоляторе», получили название КНИ-транзисторы (Silicon On Insulator, SOI). Имеется три способа изоляции: локальное окисление кремния (технология LOCOS), изоляция мелкими канавками (технология STI) и меза-изоляция. На рис. 5.3 приведена структура КНИ-транзистора.
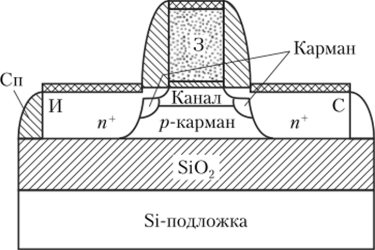
Рис. 5.3. Структура КНИ-транзистора:
И — исток; С — сток; 3 — затвор; Сп — спейсер КПИ-транзисторы имеют полностью или частично обедненное носителями основание. Вследствие обеднения подложки зарядами электрическое ноле в инверсионном слое прибора существенно меньше, чем в обычных приборах с сильнолегированной областью канала. Другим преимуществом таких структур является процесс изоляции, при котором не требуется создание изолирующих карманов. В этом случае создаются структуры с высокой радиационной стойкостью, повышенной надежностью при высоких температурах. Известные короткоканальные эффекты в таких транзисторах подавляются уменьшением толщины кремниевого слоя. Легирование канала выполняется так, чтобы получить необходимое пороговое напряжение. При этом кармашки, которые служат для предотвращения смыкания истока и стока, легируются бором для и-канальных транзисторов и фосфором для р-канальных. Эти же кармашки способствуют подавлению эффекта снижения порогового напряжения при уменьшении длины канала при переходе на меньшие топологические нормы.
Контакты к областям транзистора выполняются вольфрамом, в то время как электрическая разводка осуществляется межсоединениями из алюминия. Спейсеры из диоксида кремния служат разграничительными прослойками между транзисторными структурами.
К преимуществам этого типа транзисторов следует также добавить:
- • высокую проводимость канала вследствие малого рассеяния носителей заряда;
- • легкость управления током в тонком канале;
- • КНИ-транзисторы перспективны для создания микромощных и высокоскоростных СБИС для напряжения питания порядка 1,2 В.
К недостаткам таких КНИ-транзисторов следует отнести малую собственную электрическая емкость. В этом случае время задержки сигнала в таком вентиле меньше задержки сигнала в межсоединениях.
Инженерная мысль дальнейшее развитие КНИ-транзисторов воплотила в TeraHertz-транзисторах. Одной из разновидностей является транзистор на обедненной подложке. Конструкция предусматривает размещение транзистора не непосредственно на кремниевой подложке, а в тонком слое кремния поверх слоя изолятора. В отличие от технологии «кремний на изоляторе» (SOI) предлагаемая конструкция характеризуется тем, что верхний кремниевый слой изготавливается из кремния, полностью обедненного примесями. Такой прием позволяет снизить утечку тока через выключенный транзистор на два порядка.
Вторая конструкция транзистора основана на применении в качестве подзатворного диэлектрика высокоизолирующего материала. Эта технология получила название «осаждение атомных слоев», и с ее помощью можно формировать монослои. Известно, что в процессе миниатюризации транзисторов снижается толщина подзатворного изолирующего слоя. Это сопряжено с увеличением тока утечки. Использование высокоизолирующего материала вместо традиционного диоксида кремния позволяет уменьшить величину тока утечки на несколько порядков, а также возможность регулировать толщину слоя с точностью до мономолекулярного слоя. Однако уменьшение емкости транзистора добавлением слоя диэлектрика вглубь кремния увеличивает сопротивление между истоком и стоком. В этом случае требуется повышение напряжения, что резко ухудшает потребительские свойства транзистора и микросхемы в целом. Конструкторы нашли интересное решение. Для снижения сопротивления промежутка «исток — сток» необходимо увеличить высоту истоковой и стоковой областей (рис. 5.4).
Транзистор способен работать в 1000 раз быстрее, чем обычный нолевой транзистор с изолированным затвором. Так, частота переключения.
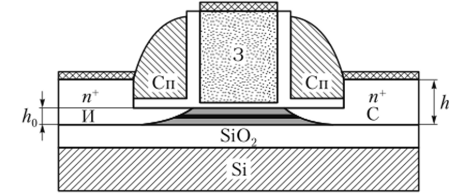
Рис. 5.4. Конструкция TeraIIertz-транзистора:
h0 — высота области исток —сток первой конструкции; h — высота области «исток — сток» второй конструкции; И — исток; 3 — затвор; Си — спейсер
TeraHertz-транзистора достигает значения 1000 ГГц, или 1 ТГц, и выше. У такого токи утечки малы, поэтому транзистор работает при очень малых рабочих токах. Для TeraHertz-транзисторов характерны низкая емкость перехода, стойкость к воздействию излучения и отсутствие эффекта плавающей подложки.
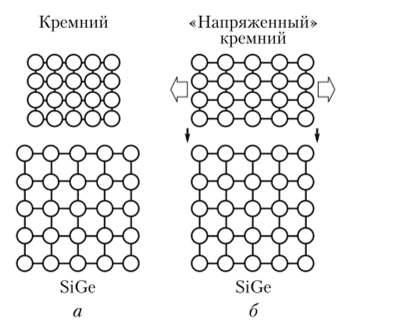
Рис. 5.5. Технология формирования «напряженного» кремния:
а — исходная структура; 6 — слой кремния на поверхности SiGe.
Транзисторы на структурах SiGe. В основе технологии создания транзистора с управляемым каналом лежит стремление атомов соединения к упорядоченной ориентации друг относительно друга. Так, в процессе осаждения кремния на подложку из материала с другой постоянной кристаллической решеткой (например, на кремний-германиевую) атомы кремния стремятся сохранить структуру в соответствии с атомами подложки. Если это расстояние больше, чем в кремнии, происходит «растяжение» атомов последнего. Другими словами, кремний оказывается «напряженным» (рис. 5.5). В этом случае скорость дрейфа электронов будет на 70% выше, чем в обычном кремнии.
Транзисторы, сформированные па базе гетеропереходов Si/Si07Ge03, получили название модуляционно легированных транзисторов с затвором Шоттки, или MODFET-транзисторов. Подвижность электронов и дырок в канале таких транзисторов достигает значения ц" = 1270-^2830 см2/В с и р = 800-^-1000 см2/Вс. Даже не изменяя размеров транзисторов, можно увеличить быстродействие чипа на 35%.
Комбинация структур Si—SiGe используется и в технологии «кремний ни на чем» (Silicon-on-Nothing, SON). Эта технология развивает достоинства технологии КНИ-транзисторов. В соответствии с этой технологией на кремниевую пластину наносят эпитаксиальный слой SiGe толщиной порядка 30 нм. Затем наносится слой кремния толщиной до 20 нм и формируется слой подзатворного оксида, поликремниевого затвора и спейсера.
Создается доступ к слою SiGe, который затем вытравливается с помощью селективного плазменного травления. Таким способом под слоем кремния создается своеобразный воздушный туннель высотой порядка 20 мк (рис. 5.6).
Многозатворные транзисторы. При разработке транзисторов с длиной канала менее 100 нм масштабируются также глубина залегания р-н-перехода, а также толщина подзатворного диэлектрика. В этом случае не исключе;
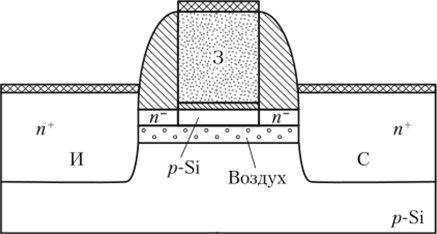
Рис. 5.6. Структура транзистора типа «кремний ни на чем»:
И — исток; 3 — затвор; С — сток, но увеличение тока туннелирования через затвор и смыкание областей истока и стока.
Одним из примеров транзистора с двойным затвором является конструкция FinFET-транзистора (Fin Field Effect Transistor). Свое название он получил из-за конструктивных особенностей. В этом приборе тонкое кремниевое тело имеет форму плавника (fin) и обернуто затвором (рис. 5.7).
Затвор формирует два самосовмегцающихся канала, расположенных с двух сторон кремниевого тела. Передняя выступающая часть тела представляет собой исток, задняя — сток. Каналы индуцируются напряжением на затворах вдоль обеих сторон пластины.
Ток в транзисторе протекает в плоскости, параллельной плоскости тела. Активная ширина прибора равна высоте тела — плавника. Это тело можно увеличивать путем параллельного включения многих столбиков, формирующих исток и сток. Таким образом, формируется активная область транзистора. Трехмерная конструкция FinFET-транзистора позволяет значительно снизить потери на тепловыделение.
Технологический процесс изготовления FinFET-транзистора предусматривает формирование методами фотолитографии плавника-вставки толщиной порядка 20 нм и высотой 180 нм. Области стока —истока изготавливаются с помощью ионной имплантации под углом 45° с четырех сторон пластины. Созданы транзисторы с длиной канала порядка 30 нм.
Разработана конструкция транзистора с тройным затвором (Tri-Gate Transistor), особенностями которого являются объемность электродов тран;

Рис. 5.7. Структура FinFET-транзистора.
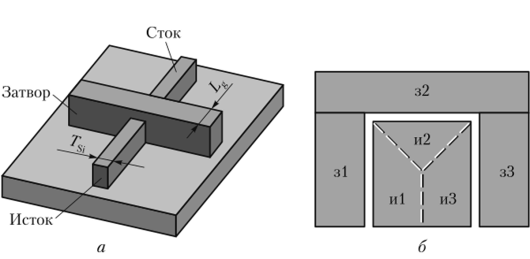
Рис. 5.8. Структура Tri-Gate-транзистора (а) и поперечное сечение области «затвор — канал» (б).
зистора, а также управление током в определенной части кремниевой подложки «своим» затвором (рис. 5.8). В этом случае удается эффективно увеличить площадь транзистора, доступную для прохождения сигнала. Тройной затвор выполняется на ультратонком слое полностью обедненного кремния. В результате обеспечиваются малый ток утечки, высокое быстродействие в процессах переключения и значительно сокращается потребляемая мощность. Чтобы обеспечить условия полного обеднения подложки носителями, необходимо подобрать соответствующее соотношение ширины и высоты тела транзистора — кремниевой вставки.
Оптимальным считается равенство двух размеров ширины и высоты тела-вставки и длины затвора транзистора. Удалось создать р- и «-канальные транзисторы с длинной затвора 60 им, шириной и высотой вставки порядка 70 нм. С помощью существующего литографического процесса удалось создать р- и «-канальные транзисторы с длиной затвора 60 нм, шириной и высотой вставки порядка 70 нм.
По 65 нм-технологии разработан трехмерный многозатворпый транзистор (Multi-Gate Fin FET). По сравнению с однозатворными планарными транзисторами удалось уменьшить площадь транзистора па 30%, а ток утечки — в 10 раз. На рис. 5.9 приведен общий вид такого транзистора, полученный в электронном микроскопе.
Рассмотренные альтернативные транзисторные структуры позволяют надеяться на дальнейшее развитие микроэлектроники, а также на становление наноэлектропных схемотехнических вычислительных устройств и систем.
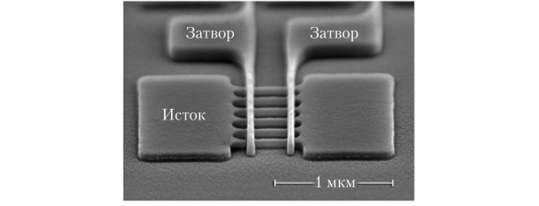
Рис. 5.9. Общий вид трехмерного многозатворного транзистора.
Гетеротранзисторы. Гетеротранзистор представляет собой транзистор, содержащий один или несколько гетеропереходов. Зонные диаграммы гетеропереходов имеют разрывы зон, которые можно использовать для ограничения движения носителей заряда в направлении, перпендикулярном плоскости гетероперехода. В гетеропереходах носители заряда ведут себя в зависимости от направления движения. Гетеропереходы формируются, как правило, с помощью тонких слоев. Поэтому в направлении, перпендикулярном слою, энергетический спектр носителей заряда имеет дискретный характер и имеет место размерное квантование. В двух других направлениях плоскости слоя спектр носит непрерывный характер и сохраняется зонная структура.
Технология полупроводниковых гетероструктур позволяет создавать системы с пониженной размерностью. Если движение носителей заряда ограничено в одном направлении, то формируется квантовая яма. В ней формируется двумерный электронный газ. Если ограничение движения носителей происходит в двух направлениях, то формируется квантовая нить. Нульмерная квантовая точка формируется в случае ограничения движения носителей, но трем направлениям.
В качестве примера на рис. 5.10 приведена конструкция гетсротранзистора. Его структура выращена методом молекулярно-лучевой эпитаксии, но технологии самосовмещения. В 2D-слое имеются подвижные электроны с ти;
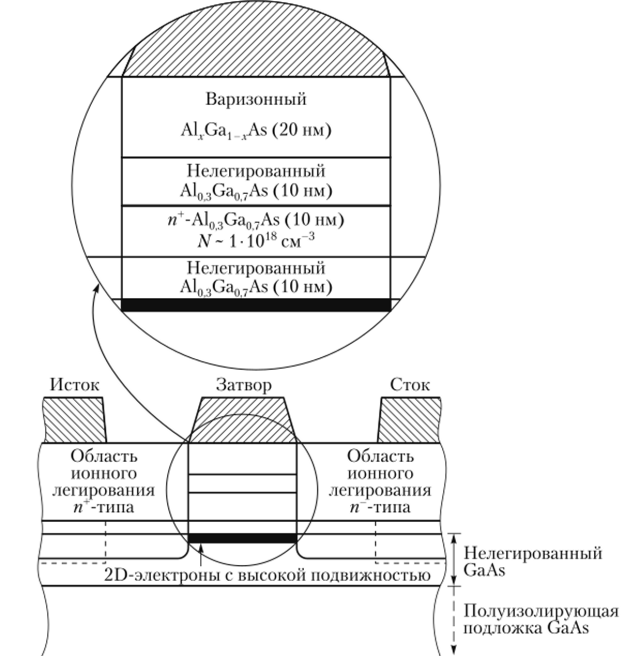
Рис. 5.10. Схема полевого гетеротранзистора на основе AlGaAs/GaAs личным значением подвижности 6500 см2/В с при 300 К и 120 000 см2/В с при 77 К. Соответствующие значения поверхностной плотности электронов составили 5,4−10″ и 7,8−10″ см 2 соответственно. Технология формирования такой структуры включала в себя формирование затвора с барьром Шоттки на основе силицида металла, ионную имплантацию, отжиг, формирование омических контактов.
Понижение размерности повышает роль межэлектронных взаимодействий. В двумерном электронном газе, в частности, наблюдаются целочисленный и дробный квантовые эффекты Холла. Обнаружены квазичастицы с электрическим зарядом, равным одной трети заряда электрона. В одномерных проводниках наблюдается квантование проводимости в отсутствие магнитного поля, возникают элементарные возбуждения с дробным электрическим зарядом, носители заряда без спина и носители спина без заряда.
Различают несколько видов гетеротранзисторов.
Гетероструктурныс полевые транзисторы с высокой подвижностью электронов, или НЕМТ-транзисторы (High Electron Mobility Transistor), имеют большую крутизну ВАХ и большую предельную частоту. В основе работы НЕМТ-транзисторов лежит идея использования «квантового колодца» в качестве канала. В квантовом колодце формируется двумерный электронный газ (ДЭГ). За счет потери одной степени свободы подвижность носителей увеличивается примерно вдвое, возрастает и эффективная концентрация носителей. Чаще всего гетеропереход формируется из широкозонного полупроводника AlvGa,_rAs и более узкозонного z'-GaAs. На их границе происходит разрыв энергетического уровня Ес на величину приблизительно ДЕс = 0,38 эВ. В качестве подзатворного диэлектрика используется широкозонный полупроводник AlGaAs, который вследствие искривления энергетических зон становится обедненным электронами (рис. 5.11, а).
Между металлическим затвором и расположенным под ним слоем AlvGa,_vAs образуется управляющий переход «металл — полупроводник». Канал нормально открытого транзистора формируется в слое нелигпрованного GaAs на границе гетероперехода в области формирования двумерного электронного газа. Канал представляет собой потенциальную яму, образованную в узкозонном проводнике на границе с более широкозонным.
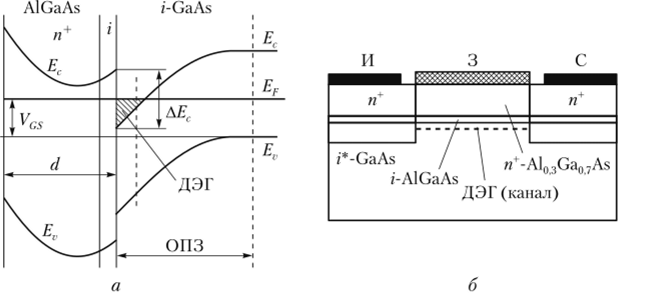
а б.
Рис. 5.11. Зонная диаграмма перехода Al0 3Ga0-As/GaAs (а) и структура НЕМТ-транзистора на его основе (б):
ДЭГ — двумерный электронный газ; ОПЗ — область пространственного заряда В этом канале речь идет о поверхностной плотности электронов, которая составляет ~2 • 1012 см 2.
Под действием управляющего напряжения изменяются толщина обедненной области перехода, концентрация электронов и соответственно ток стока. При достаточно большом отрицательном напряжении на затворе обедненная область расширяется и может перекрыть область насыщения в канале. Ток стока при этом прекращается.
Различают НЕМТ-транзисторы с псевдоморфными и метаморфными гетеропереходами. Переход называется псевдоморфным, если не соблюдается соответствие параметров кристаллической решетки слоев гетероперехода. В этом случае один из слоев делается очень тонким, и его кристаллическая решетка растягивается до соответствия другому материалу. Образуется структура с увеличенной разницей в ширине запрещенной зоны. Приборы на таких структурах обладают более высокой производительностью.
В метаморфном гетеропереходе совмещение материалов происходит через буферный слой, например AlInAs. Концентрация индия выбирается такой, чтобы постоянная решетки буферного слоя была близка обоим слоям гетероструктуры. В этом случае путем выбора концентрации индия транзистор может быть оптимизирован для конкретных применений. Так, при низкой концентрации индия получаются малошумящие транзисторы, а при высокой — транзисторы с большим коэффициентом усиления.
Конструкция НЕМТ-транзистора представлена на рис. 5.11, б. За более чем четвертьвековую историю НЕМТ-транзисторы развились в семейство. Помимо соединений А3В5 весьма перспективными оказались соединения InGaAs, InGaP, InAlAs, InP. Соединения на основе индия отличаются высокой подвижностью электронов, разрыв зоны проводимости АЕс достигает 0,5 эВ.
Разработаны п- и канальные НЕМТ-транзисторы, для которых создается потенциальная яма для дырок в узкозонном слое, например InGaP.
Для использования в мощных СВЧ-устройствах, работы в экстремальных условиях разработаны НЕМТ-транзисторы на основе GaN и SiC. Обычно канал у таких транзисторов формируется в узкозонном слое AlGaN. По частотным и усилительным свойствам НЕМТ-транзисторы на основе AlGaN/GaN уступают транзисторам на соединениях AlGaAs/GaAs, однако превосходят их по плотности снимаемого тока, мощности и рабочему напряжению истока — стока. В НЕМТ-транзисторах достигаются частоты порядка 270 ГГц и крутизна характеристики до 2000 мс/мм.
Гетеропереходные полевые транзисторы с затвором Шоттки (ГПТШ). Создание гетероиереходных полевых транзисторов с затвором Шоттки на AlGaN/GaN является одним из главных направлений СВЧ-полупроводниковой электроники.
Основным элементом такой структуры является область двумерного газа в квантовом колодце. Эта область располагается непосредственно под гетеропереходом. Подвижность в этой области составляет порядка 2000 см2/В с, а концентрация носителей -1013 см 2.
Структура ГПТШ представлена на рис. 5.12. Буферный слой (Sab-buff) улучшает параметры ДЭГ, препятствует переходу электронов ДЭГ на поверхностные состояния и объемные дефекты. Созданные конструкции.
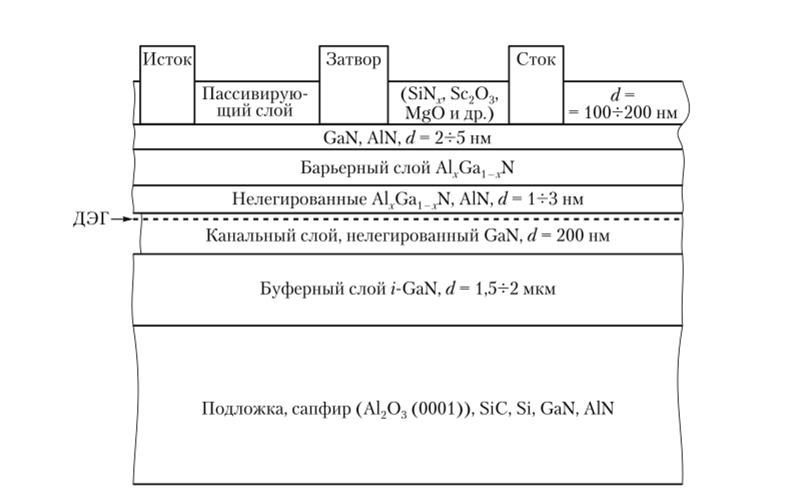
Рис. 5.12. Типовая структура ГПТШ на GaN:
ДЭГ — двумерный электронный газ ГПТШ позволяют получить выходную мощность порядка 8 Вт на частоте порядка 4 ГГц.
Одной из проблем GaN-технологии является нестабильность тока стока при его увеличении. Это явление получило название коллапс-тока. Оказалось, что этот эффект связан с наличием ловушечных центров на поверхности и в объеме материала буферного GaN-слоя. С этой целью пассивируют поверхность диэлектрической пленкой SiNr, а также формируют cap-слой.
Транзисторы на соединении GaN, ширина запрещенной зоны которых 3,4 эВ, сохраняют работоспособность до температур 500—600°С. На основе GaN-транзисторов создаются монолитные интегральные схемы СВЧ-диапазона.
Полевые транзисторы (Field Effect Transistor), или FET-транзисторы, характеризуются максимальной удельной крутизной ВАХ, а также предельной частотой. При уменьшении длины канала и снижении сопротивлений пассивных областей стока R. и истока RH эти параметры улучшаются. Предельные значения gmax и /, пропорциональны предельной дрейфовой скорости Едр и подвижности носителей в канале. Подвижность составляет 3500 см2/В • с, что в пять раз выше, чем у кремния, поэтому полупроводниковое соединение А3В5 и гетероструктуры на его основе предпочтительнее кремниевых транзисторов. Наиболее популярным активным элементом является n-канальный полевой транзистор с затвором Шоттки на арсенид-галиевой структуре (MESFET) (рис. 5.13).
Активный слой формируется методом ионной имплантации доноров в полуизолирующую подложку. Затвор Шоттки формируется в виде золотого контакта. Пороговое напряжение такого транзистора зависит от степени легирования, толщины канала, а также расстояния от затвора до канала и лежит в пределах от -4 В до +0,2 В. В качестве подзатворного диэлектрика используется обедненная электронами область пространственного заря;
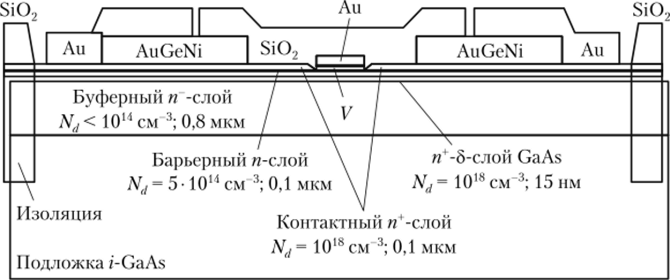
Рис. 5.13. Структура MESFET-транзистора на основе GaAs.
да под барьером Шоттки. Канал представляет собой тонкий сильно легированный слой n+-GaAs, расположенный между легированным активным слоем и подложкой.
Транзисторы этого типа имеют длину канала порядка 0,13 мкм и работают на частоте 50 ГГц. К недостаткам MESFET-транзистора следует отнести трудности создания p-канальных транзисторов для формирования комплиментарных структур. Другим недостатком является невозможность использования максимальной подвижности электронов в канале (-8000 см2/Вс) при концентрации доноров -1018 см-3. В разработках нолевых транзисторов используются гетероструктуры на основе GaAs—FIGaAs, InGaAs—InP, InGaAs—AlGaAs, AlGaSb—InAs. Заметим, что у соединения InAs подвижность электронов вдвое превосходит это значение у GaAs.
Гетероструктурный транзистор на квантовых точках. Под квантовыми точками будем понимать нанометровые фрагменты проводника или полупроводника, ограниченные по всем трем пространственным измерениям и содержащие электроны проводимости. Каждая квантовая точка имеет свой спин и способна поглощать и испускать электроны.
Модулированно-легированные гетероструктуры с квантовыми точками, встроенные в токовый канал, представляют значительный интерес для устройств как для микро-, так и для наноэлектроники. Транзисторы на квантовых точках представляют, но существу новый тип приборов на горячих электронах, весьма перспективный для СВЧ-электроники.
На рис. 5.14 представлена структура модулированно-легированого транзистора с квантовыми точками. Такие гетероструктуры растят по модели Странски — Крастанова, при которой эпитаксиальный слой формируется на подложке с другими параметрами решетки. Квантовые точки формируют в слое, если его толщина превышает некоторое критическое значение.
На нолуизолирующую подложку GaAs (100) методом молекулярно-лучевой эпитаксии наносится нелегированный буферный слой GaAs толщиной -0,5 мкм. Затем наносятся два тонких слоя InAs, которые разделяются нелегированным «спейсер"-слоем GaAs. Толщина слоев InAs составляет от 0,7 до 1,0 нм, а слоя GaAs — от 3,5 до 5,6 нм. При этом формировалось два слоя квантовых точек. Размер квантовых точек и их плотность варьировались в различных структурах. Затем выращивался второй «спейсер"-слой Al02Ga08As толщиной 10 нм. Далее выращивались слои: 5(51)-легированный и нелегированный слой Al09Ga08As толщиной 35 нм.
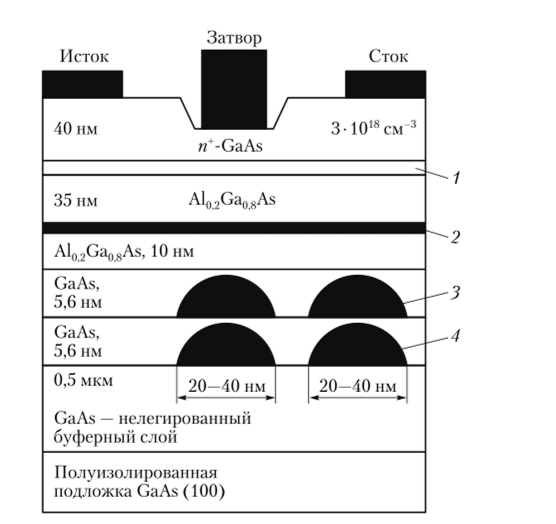
Рис. 5.14. Структура модулированно-легированного транзистора с квантовыми точками:
1 — нелегированный слой (6 нм) GaAs; 2 — 8-слой Si; 3,4 — слои InAs.
Формирование такой гетероструктуры завершалось выращиванием нелегированного слоя GaAs толщиной 6 нм и легированного кремнием (и1 = = 310|Н см'2) контактного слоя GaAs толщиной 40 нм. После нанесения электродов транзистор был готов к исследованиям. Длина затворов составляла 0,3—0,4 мкм. Выяснилось, что подвижность и концентрация электронов в двумерном газе уменьшаются из-за наличия квантовых точек. Это означает, что квантовыми точками захватывается меньшее число электронов.
Транспорт электронов в гетероструктурах с квантовыми точками имеет две компоненты. Одна компонента формируется подвижными электронами из двумерного газа и соответствует насыщению их дрейфовой скорости. Другая компонента обусловлена электронами, локализованными в квантовых ямах. Она дает вклад в электронный транспорт только в сильных электрических полях.
В транзисторах на квантовых точках концентрация участвующих в транспорте электронов в сильных полях не зависит от напряжения на затворе. Пороговое же напряжение, необходимое для эмиссии электронов из квантовых точек, уменьшается, когда напряжение на затворе становится отрицательным.
Если в МОП-транзисторных структурах происходит запирание транзистора при отрицательных напряжениях на затворе, то в транзисторах на квантовых точках ток стока в области малых напряжений на стоке имеет тенденцию к увеличению. Такой тип транзисторов принципиально отличается от всех известных полевых транзисторов. Подобные приборы имеют высокую крутизну gmm ~ 500 мСм/мм, что позволяет разработчикам электронной аппаратуры надеяться на их использование в СВЧ-приборах.
Биполярные транзисторы. В современной микрои наноэлектронике МОП-транзисторы занимают ведущее положение. Однако в СВЧ-электронике, сотовых телефонах наибольшее значение придают биполярным транзисторам на гетеропереходах (Heterojunction Bipolar Transistor, НВТ). Конструктивно НВТ-транзистор выполняется на основе GaAs в вертикальном исполнении и поэтому занимает мало места. Типовая структура GaAs-IIBT представлена на рис. 5.15.
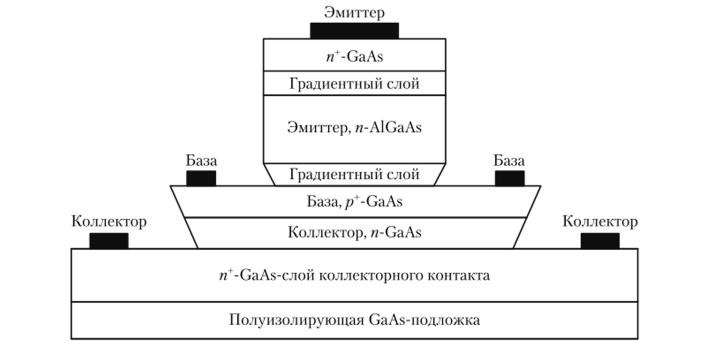
Рис. 5.15. Структура биполярного транзистора на гетеропереходах.
На GaAs-подложке с высоким сопротивлением формируется коллекторный слой и-GaAs с концентрацией примесей 3−1016 см'3. Затем наносится базовый сильнолегированный слой p-GaAs с концентрацией примеси до К)19 см Через градиентный слой формируется эмиттер из и-AlGaAs, ширина запрещенной зоны которого выше, чем в GaAs базовой области. В области омических контактов эмиттера формируют дополнительные высоколегированные слои и'-GaAs. Заметим, что слои транзистора формируются в процессе эпитаксии, поэтому требования к литографическим процессам невысоки. Это удешевляет транзистор.
Вследствие различных запрещенных зон в базе и эмиттере в электроннодырочном переходе образуется скачки потенциалов, различные для прохождения электронов п дырок. Стимулируется инжекция электронов из эмиттера в базу и сокращается поток дырок из базы в эмиттер. Высокий уровень легирования базы и низколегированный эмиттер способствуют снижению сопротивления базы и емкости перехода «эмиттер — база». Этим объясняются высокочастотные свойства НВТ-транзисторов.
Акцент на процессы эпитаксии позволил формировать транзисторные структуры с двумя гетеропереходами (Double НВТ). Эти транзисторы отличает более высокое напряжение пробоя, но граничная частота снижается. Появились приборы на основе фосфида индия, которые могут работать в частотном диапазоне до 250 ГГц.
Рассмотрение наиболее распространенных приборов микрои наноэлектроники показывает, что имеющиеся технологии в целом обеспечивают современные потребности приборов пикосекундного быстродействия. Использование гетероструктур позволяет улучшить совокупность параметров и характеристик массовых приборов современной электроники — полевых и биполярных транзисторов. Отметим, что в вопросах создания сверхскоростных интегральных схем и твердотельных схем МВЧ-диапазона на основе гетероструктур еще предстоит провести большой объем фундаментальных и прикладных исследований. Среди таких проблем — вопросы объединения кремниевой электроники со структурами на гетеротранзисторах.