Факторы, определяющие скорость и селективность травления

Продолжительность пребывания — мера средней продолжительности нахождения молекул в плазме. При обычных условиях протекания процесса скорость потока рабочего газа оказывает незначительное воздействие на скорость травления. Это влияние проявляется при экстремальных условиях, когда-либо скорость потока настолько мала, что скорость травления лимитируется доставкой травитсля к подложке, либо скорость… Читать ещё >
Факторы, определяющие скорость и селективность травления (реферат, курсовая, диплом, контрольная)
Энергия и угол падения ионов. Интенсивность процесса ионного физического распыления в значительной степени определяется энергией ионов и углом их падения на поверхность. Типичные значения интенсивности физического распыления для материалов, применяемых в ионно-плазменных процессах производства ИС, при использовании ионов Аг+ с энергией 500 эВ составляют ~ 0,5…1,5. Следовательно, селективность ионного травления низкая.
При плазменном и радикальном ионно-плазменном травлении процесс физического распыления способствует увеличению скорости травления, но это увеличение незначительно. Существенно большую роль играет эффект, оказываемый атомными (ионными) соударениями на протекающие на поверхности химические реакции.
Стимулируемые ионами химические реакции между электрически нейтральными травящими частицами, образованными в разряде, и поверхностью твёрдого тела играют доминирующую роль во многих процессах сухого травления.
На Рис. 5.10 представлена временная зависимость скорости ионно-ускоренной реакции травления.
В рассматриваемом процессе независимые пучки ионов Аг' с энергией 450 эВ и XeF2 бомбардировали поверхность подложки кремния Si имели низкую скорость травления. Здесь ионы Аг+ осуществляют травление за счет физического распыления, а травящее действие молекул XeF2 обеспечивается их диссоциацией на поверхности с образованием десорбируемого Хе и двух атомов фтора F. Атомы F вступают в самопроизвольные реакции с Si, в результате которых образуются летучие фториды кремния. Такие физико-химические процессы на поверхности приводят к существенному повышению скорости её травления (в восемь раз) за счет проявления стимулирующего эффекта ионного облучения.

Рис. 5.10. Временная зависимость скорости травления кремния для ионно-стимулирующей реакции на этапах травления: I — газом XeF2; 11- одновременно газом XeF2 и пучком ионов Аг+; 111 — пучком ионов Аг+.
На Рис. 5.11 представлена зависимость скорости возбуждаемой реакции травления Si ионами Аг*и СЬво времени.
В отличие от атомов F молекулы С12 нс вступают самопроизвольно в реакции с Si, однако при одновременном облучении поверхности ионами Аг происходит травление Si с образованием газообразного SiCU.
Для объяснения зависимости скорости химической реакции от ионного облучения можно рассмотреть ряд механизмов:
- — ионная бомбардировка создает на поверхности дефекты, катализирующие хемосорбцию или химическую реакцию;
- — ионная бомбардировка обеспечивает непосредственную диссоциацию молекул травящих газов (например, XeF2 или СЬ);
- — ионная бомбардировка способствует удалению нелетучих остатков, замедляющих травление.

Рис. 5.11. Временная зависимость скорости травления кремния для ионно-возбуждаемой реакции. Этапы травления: 1 — пучком ионов Аг *; 11 — одновременно пучком ионов Аг‘ и газом СЬ
Относительный вклад этих и других возможных механизмов до сих пор является объектом исследований. Однако, известно, что облучение ускоренными ионами сопровождается образованием дефектов решётки, термоударом и молекулярной диссоциацией. Эти процессы способны значительно ускорить или даже возбудить химические реакции между электрически нейтральными травитслями и поверхностью материала.
В первом случае (XeF2 + Si) травление осуществляется самопроизвольно (т.е. в отсутствие ионной бомбардировки) реакционноспособным веществом (атомами F), но скорость реакции повысилась в результате облучения ионами.
Во втором случае (СЬ + Si) травление в отсутствие ионной бомбардировки вообще не происходило.
Первый случай рассматривается как ионно-ускоряющая реакция, а второй — как ионно-возбуждаемая реакция.
Эти примеры показывают, что влияние ионного облучения на скорость травления обусловлено физическими процессами, поскольку не существует механизма химического воздействия ионов инертных газов.
При энергии 1 кэВ ионы аргона Аг+ значительно эффективнее, чем ионы неона Ne~, эффективность которых в свою очередь выше, чем ионы гелия Не+, в стимулировании реакций XeFe + Si и СЬ + Si. Более высокая эффективность тяжелых ионов позволяет предположить, что для ускорения травления имеют значение физические процессы, связанные с передачей импульса.
При травлении в плазме CF4 и аналогичных газов сами образующие ионы являются потенциально реакционноспособными элементами (например, СБз+). Исследования травления кремния XeFi при одновременной ионной бомбардировке показали, что скорость травления практически не меняется при замене ионов Аг+ на ионы CF3″. Таким образом, ионы высокой энергии способны ускорять или возбуждать реакции травления посредством физических процессов, которые не зависят от природы самих ионов.
Явления, происходящие при травлении в реактивных плазмах, можно объяснить тем, что травящие компоненты (в основном электрически нейтральные), возникающие в процессе разряда, адсорбируются на поверхности и вступают с ее атомами в химические реакции, в ходе которых создаются десорбирующиеся соединения. Причем скорость всего процесса может быть повышена (или реакции могут возбуждаться) за счет воздействия образующихся в плазмах ионов высокой энергии.
Очевидно, что степень, в которой ионы повышают скорость реакций, зависит от вида травящих газов, подвергаемых травлению материалов и рабочих параметров процесса.
Состав рабочего газа. Состав рабочего газа — определяющий фактор скорости и селективности при плазменном и реактивном травлении. В технологии СБИС для травления применяются в основном галогеносодержащие газы, за исключснием процессов, связанных с удалением фоторезиста и переносом рисунков в органические слои, когда используют плазму 02. Выбор этих газов отражает тот факт, что образование летучих и квазилетучих соединений с галогенами возможно при комнатных температурах. Эти газы наиболее удобны и безопасны в работе (Таблица 5.1).
Таблица 5.1.
Материалы. | Рабочие газы. |
Si. | CF4, CF4 + 02, SF6, SF6 + 02, NF3, Cl2, CC13F. |
SiCb, SisN4. | cf4. cf4 + H2, C2 F(" c3f8, chf3 |
Al, Al-Si, Al-Cu. | CC14, CCL, + Cl2, SiCLt, BC13 |
Для реактивного травления часто применяют многокомпонентные смеси, представляющие собой обычно главную компоненту с одной или более добавками, которые вводятся для обеспечения наряду с требуемой скоростью травления другие заданные характеристики: селективность, однородность, профили края. Примером влияния таких добавок на скорость травления служит плазменное травление Si и Si02 в смесях, содержащих CF4.
Скорость травления Si и SiCb в плазме CF4 относительно низкая. При добавления в рабочий газ кислорода СЬ резко возрастает (Рис. 5.12) имеется максимум скорости травления: для Si при 12% О2 и для SiCb при 20% СЬ. При увеличении концентрации СЬ скорость снижается.
Эти явления можно объяснить, если рассмотреть химические реакции, протекающие на поверхности твердого тела и в плазме. Атомы образуются за счет диссоциации молекул CF4, вызванной соударениями с электронами, и рекомбинируют путем присоединения к радикалам CFX (х < 3).
Скорость этих процессов в чистой (без добавок) плазме CF4 такова, что равновесная концентрация атомов F низкая, а поскольку эти атомы обеспечивают протекания реакции травления, скорость травления также низкая. Добавление кислорода приводит к уменьшению количества радикалов CFX за счет образования COF4, СО и С02, что уменьшает скорость рекомбинации атомов F. В результате этого концентрация атомов F возрастает до 23%, вызывая соответственно повышение скорости травления. При увеличении добавки кислорода концентрация атомов уменьшается пропорционально уменьшению концентрации CF4 в газовой смеси.
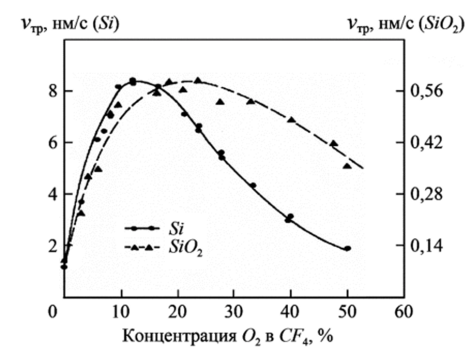
Рис. 5.12. Влияние добавления 02 в плазму CF4 на скорость травления Si и Si02.
Если бы добавка кислорода оказывала влияние только на химические процессы в плазме, следовало бы ожидать, что максимальная скорость травления как Si, так и Si02 достигалась бы при такой концентрации 02, которая обеспечивает максимальную концентрацию атомов фтора в плазме. Однако значение максимальной скорости травления Si и Si02 не совпадают, что можно объяснить участием кислорода в поверхностных химических процессах. В случаи травления кремния наблюдается тенденция хемосорбции кислорода на поверхности, в результате чего прямой доступ атомов F к поверхности частично блокируется.
Такая блокировка увеличивается при возрастании концентрации кислорода и максимальная скорость травления Si наблюдается при меньшей концентрации кислорода 23%. Этот эффект отсутствует при травлении Si02, поскольку поверхность оксида уже обогащена кислородом. Поэтому максимальная скорость травления соответствует добавке кислорода, обеспечивающей максимальную концентрацию атомов F. Хемосорбция кислорода вызывает более быстрое снижение скорости травления Si по прохождению максимума (Рис. 5.12).
Атомы фтора вступают в реакцию с кремнием быстрее, чем с Si02, поэтому плазма CF4-O2 характеризуется высокой селективностью травления Si по отношению к Si02.
При добавлении в плазму CF4 водорода Н2 наблюдается явление совершенно другого рода. В процессе реактивного ионного травления при относительно низком давлении скорость травления Si02 почти постоянна для добавок Н2, нс превышающих 40%, в то время как скорость травления Si монотонно уменьшается почти до нуля при концентрации Н2 > 40% (Рис. 5.13).
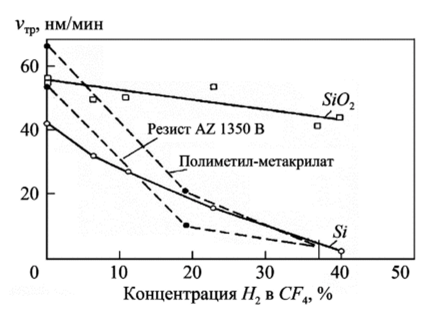
Рис. 5.13. Влияние добавления Н2 в плазму CF4 на скорость травления Si и Si02.
Добавки водорода свыше ~ 40% приводит к нежелательному образованию полимеров на поверхности SiCK.
При реактивном ионном травлении в плазме CF4-O: достигается селективность травления S1O2: Si порядка 40: 1. В процессе плазменного травления при более высоком давлении (~133/7д) добавка Нт способна одновременно повысить скорость травления SiO? и понизить скорость травления Si. И в этом случаи селективность травления SiCK: Si регулируется изменением содержания водорода в рабочем газе.
Эти эффекты можно объяснить следующим образом. Травление SiO: осуществляется в ходе ионно-возбуждаемой реакции радикалами CFX (х < 3), возможно, с участием диссоциативной хемосорбции, которая приводит к образованию SiF4. Выделяемый из радикалов углерод удаляется с поверхности, соединяясь с кислородом, содержащемся в SiCb, с образованием газов СО, СОт и, возможно COF2. При травлении кремния аналогичные реакции происходить не могут, т.к. отсутствует возможность удаления адсорбированного углерода, который препятствует травлению, т. е. блокирует доступ фтора к поверхности.
Роль водорода двойственна: с одной стороны, вступая в реакцию с атомами F, он образует стабильное соединение HF, в результате чего уменьшается концентрация потенциального травителя кремния; с другой, особенно при высоком давлении, Н2 изменяет химический состав плазмы, способствуя повышению концентрации в ней травящих радикалов CFV. В целом этот процесс может быть описан следующими реакциями:

т.е. образуется адсорбируемый углерод на Si.
В целом скорость и селективность травления Si и SiCb можно регулировать при травлении в реактивной плазме CF4 путем добавления окисляющих и восстанавливающих компонент в рабочий газ. При добавлении окислителей ускоряется травление Si по отношению Si02, добавка восстановителей обеспечивает обратную селективность.
Давление рабочего газа и плотность мощности электрического поля. Влияние каждого из этих параметров на процесс травления иногда трудно объяснить или предсказать. Однако являются очевидными несколько общих тенденций.
Понижение давления рабочего газа и повышение плотности мощности приводит к увеличению средней энергии электронов и ионов. Повышение плотности мощности вызывает также повышение плотности радикалов и ионов в плазме. Таким образом, в процессах ионно-стимулируемого травления путем уменьшения давления или увеличения мощности можно повысить степень анизотропии скорости травления.
Как правило, с увеличением мощности, скорость травления монотонно возрастает, хотя темп приращения замедляется. Почти вся прикладываемая мощность, в конечном счете, рассеивается в виде тепла, поэтому при обеспечении очень большой плотности мощности электрического поля необходимо предусматривать охлаждение подложек во избежание нежелательных последствий нагрева, таких, как плавление и подгорание фоторезиста или потери селективности травления.
Скорость потока рабочего газа определяет максимальный возможный приток к подложке реакционно-способных компонент. В действительности приток зависит от равновесия между процессами генерации и рекомбинации в плазме активных элементов, что обсуждалось выше. Одним из механизмов потерь травящих компонент — унос их вязким газовым потоком. Скорость потерь обратно пропорциональна продолжительности пребывания /г, определяемой как: 
где Р — давление, Па; V и F — объем плазмы и скорость газового потока соответственно.
Продолжительность пребывания — мера средней продолжительности нахождения молекул в плазме. При обычных условиях протекания процесса скорость потока рабочего газа оказывает незначительное воздействие на скорость травления. Это влияние проявляется при экстремальных условиях, когда-либо скорость потока настолько мала, что скорость травления лимитируется доставкой травитсля к подложке, либо скорость травления столь велика, что унос газовым потоком становится доминирующим механизмом потерь активных компонент. Возможность реализации последней ситуации зависит от скорости откачки, вязкости рабочего газа и вида материалов, находящихся внутри реактора. Если время жизни активных компонент мало (вследствие проявления других механизмов потерь), влиянием скорости газового потока можно пренебречь. Такая ситуация типична, когда в роли активной компоненты выступает атомарный хлор. Влияние скорости потока на скорость травления может проявиться при использовании травящих компонент с более длительным временем жизни, например атомов фтора.
На (Рис. 5.14) представлена зависимость величины, обратной скорости травления HR от скорости потока газовой смеси CF4— СЬ при травлении SiCb и Si3N4.
Время жизни активных компонентов определяется уносом их газовым потоком.
Наблюдаемая линейная зависимость соответствует обратной зависимости продолжительности пребывания травящих компонент в плазме от скорости потока.
Температура. Температурная зависимость скорости реактивного травления определяется главным образом влиянием температуры на скорость протекания химических реакций.
Скорость травления R при малых значениях энергии активации Q < 0,5 эВ/М описывается известной зависимостью Аррениуса:

где Q — энергия активации; Т — абсолютная температура подложки; к — постоянная Больцмана.
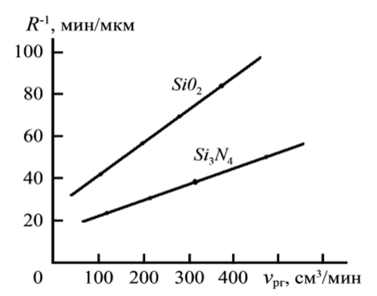
Рис. 5.14. Зависимость величины обратной скорости травления MR от скорости потока рабочего газа в процессе травления плазмой CF4— 4% 02 при давлении 133 Па.
Для обеспечения однородных и воспроизводимых скоростей травления необходимо контролировать температуру подложки. Основной причиной нагрева теплоизолированных подложек является их разогрев плазмой, а также выделяемое тепло в результате протекания экзотермических реакций травления.
Загрузочный эффект. При реактивном травлении иногда наблюдается уменьшение скорости травления при увеличении суммарной площади поверхности, подвергаемой травлению — это так называемый загрузочный эффект.
Это происходит в тех случаях, когда активные компоненты быстро вступают в реакцию с подвергаемым травлению материалом, но обладают длительным временем жизни в отсутствии этого материала. В этом случаи доминирующим механизмом потерь активных компонент является само травление, поэтому, чем больше площадь подвергаемой травлению поверхности, тем выше скорость потерь. Скорость образования активных компонент определяется рабочими характеристиками процесса (давлением, мощностью, частотой и т. д.) и почти не зависит от количества подвергаемого травлению материала в реакторе. Таким образом, средняя концентрация активных компонент, равная разности скоростей образования и потерь, уменьшается с увеличением площади поверхности, подвергаемой травлению.
Зависимость R от площади подвергаемой травлению поверхности Ф при травлении одним активным веществом имеет вид:

где fi — постоянная скорости реакции; г — время жизни активного вещества в отсутствие подвергаемого травлению материала; G — скорость образования активного вещества; /См — коэффициент, постоянный для данных материалов и геометрии реактора.
Из выражения (5.5) следует, что загрузочный эффект заметно не проявляется, пока Км ? J3 Т-Ф " . Это условие удовлетворяется при использовании плазмы, в которой собственное время жизни г активных компонентов очень мало, т. е. когда превалирует иные, но отношению к самому травлению механизмы потерь.
Проблема, связанная с загрузочным эффектом, возникает при контроле размеров элементов в условиях бокового травления. В связи с тем, что при стравливании до конца заданного слоя площадь подвергаемой травлению поверхности резко уменьшается, в процессе перетравливания скорость травления немого превышает номинальную. Это существенно затрудняет контроль размеров элементов, так как при таких условиях осуществляется ускоренное боковое травление.