Гальваномагниторекомбинационные преобразователи.
Информационно-измерительная техника и электроника.
Преобразователи неэлектрических величин

Где Cs — число электронно-дырочных пар, исчезающих каждую секунду на единице площади поверхности, или величина, характеризующая поверхность (число поверхностных состояний); Ans — концентрация избыточных носителей вблизи поверхности. Таким образом, скорость поверхностной рекомбинации имеет размерность скорости и определяется концентрациями центров рекомбинации на поверхности и носителей заряда… Читать ещё >
Гальваномагниторекомбинационные преобразователи. Информационно-измерительная техника и электроника. Преобразователи неэлектрических величин (реферат, курсовая, диплом, контрольная)
Гальваномагниторекомбинационный (ГМР) эффект
ГМР-эффект относится к магниторекомбинационным явлениям и заключается в следующем. В полупроводнике с током, помещенном в магнитное поле, под действием силы Лоренца пары носителей отклоняются и скапливаются у одной из поверхностей, тогда как у противоположной поверхности концентрация электронно-дырочных пар уменьшается. Если скорость рекомбинации на одной грани больше, чем на другой, то при отклонении носителей к этой грани наблюдается резкое убывание тока с ростом магнитного поля [14]. Относительное изменение проводимости вдоль оси X (рис. 10), обусловленное изменением средней по сечению образца концентрации носителей заряда, равно.


где.
q-заряд электрона; b = Рр/р"; рр, рп — подвижности электронов и дырок; п0, р0 — концентрация электронов и дырок в образце при В=0; к — постоянная Больцмана; Ттемпература окружающей среды; dширина образца; В7 — магнитная индукция вдоль оси z; Ех — напряженность электрического поля вдоль оси х; Ld= т[Ё)т — длина биполярной диффузии; т — время жизни носителей, Lso и Lsd — длины диффузионных пробегов носителей в направлении соответствующих граней.
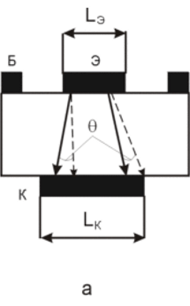

Рис. 7. Конфигурация кармана для изготовления интегрального ДХ и его токовые (1) и холловские (2) контакты.
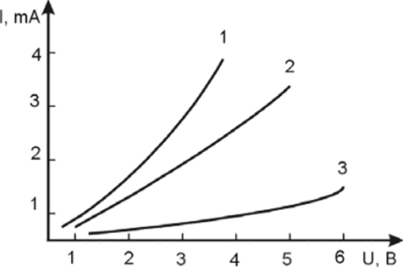
Рис. 8. ВАХ магнитодиода КД 303 при разных значениях и направлениях магнитной индукции В: 1) В=0 Тл; 2) В = - 0.2 Тл; 3) В=0.2 Тл.
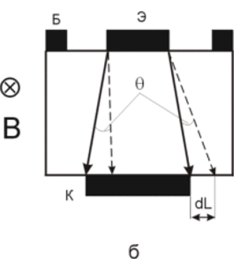
Рис. 9. Изменение траектории движения инжектированных носителей в магнитном ноле в р-п-р биполярном транзисторе с узкой (а) и широкой (б) базой.

где г — зависит от механизма рассеяния, например, при рассеянии на ионизированных примесях г=3/2; S0 и Sd — скорость поверхностной рекомбинации на противоположных гранях образца.
Как видно из формул (28, 29), относительное изменение проводимости образца под действием магнитного поля обращается в нуль при равенстве скоростей поверхностной рекомбинации на обеих гранях и достигает максимума при Sd/So —> °о. Чтобы объяснить полученный результат, необходимо вспомнить о самом понятии скорости поверхностной рекомбинации.
Энергетическая структура поверхности любого полупроводника всегда отличается от объемной, что обусловлено наличием в запрещенной зоне определенных разрешенных уровней энергии, связанных с обрывом кристаллических связей на поверхности (уровни Тамма), наличием на ней дефектов и дислокаций, адсорбированных атомов и молекул. Вся совокупность этих энергетических уровней называется поверхностными состояниями. Концентрация поверхностных состояний, связанная с уровнями Тамма, обусловлена кристаллической структурой полупроводника и для данного материала является постоянной. Концентрация же остальных поверхностных состояний определяется качеством обработки поверхности, ее защитой и составом окружающей среды (величина переменная). В зависимости от своего расположения в запрещенной зоне полупроводника относительно уровня Ферми энергетические уровни поверхностных состояний могут служить ловушками захвата или центрами рекомбинации.
Центрами рекомбинации служат поверхностные состояния, энергетические уровни которых расположены вблизи середины запрещенной зоны под уровнем Ферми, а следовательно, заполнены электронами. Тогда при захвате на них дырки из валентной зоны происходит акт рекомбинации. Скорость поверхностной рекомбинации определяется как.

где Cs — число электронно-дырочных пар, исчезающих каждую секунду на единице площади поверхности [см'2 • с'1], или величина, характеризующая поверхность (число поверхностных состояний); Ans — концентрация избыточных носителей вблизи поверхности [см'3]. Таким образом, скорость поверхностной рекомбинации имеет размерность скорости [см/с] и определяется концентрациями центров рекомбинации на поверхности и носителей заряда, подходящих к ней.
Рассмотрим теперь плоский образец полупроводника, вдоль которого протекает ток, причем образец однородный и, следовательно, линии тока параллельны его граням и концентрация носителей одинакова во всем объеме, если нс учитывать влияние поверхностей. Однако на поверхности происходит рекомбинация электронно-дырочных пар, а, следовательно, вблизи нее этих пар будет не хватать, т. е. создается градиент концентрации от поверхности к центру образца. Если скорости поверхностной рекомбинации на обеих гранях образца одинаковые, то градиенты концентрации от одной и от другой грани образца будут одинаково искривлять траектории движения носителей. Если теперь приложить к образцу магнитное поле, то за счет силы Лоренца концентрация носителей у одной из граней увеличивается, а у другой уменьшается, за счет чего на первой скорость поверхностной рекомбинации возрастает, а на второй уменьшается. Однако общее число рекомбинирующих пар не изменится, и проводимость образца может измениться только за счет искривления траектории движения носителей, что является обычным магниторезистивным эффектом. Однако, если скорость поверхностной рекомбинации на одной грани образца существенно больше, чем на другой, то помещение образца в магнитное поле приведет к существенному росту на этой грани поверхностной рекомбинации, а это значит, что под действием магнитного поля концентрация носителей в образце будет уменьшаться, что приведет к уменьшению проводимости. Это явление и носит название гальваномагниторекомбинационного эффекта.
При выполнении условия Sd«S() в режиме постоянного тока и в слабых магнитных полях, исходя из уравнения (28), падение напряжения на гальваномагниторекомбинационном элементе (ГМРЭ) можно представить в виде.

где Е — напряженность электрического поля, В — магнитная индукция, I — длина ГМРЭ, (Хв — константа, определяемая физическими параметрами полупроводника; J0, Ro — ток через образец и его сопротивление при В=0;
Величина ав при заданных LD, р, b и Т достигает максимума при d =1 .4Ld и п0=ро и принимает вид.


Следует отметить, что введение понятия скорости поверхностной рекомбинации возможно при условии отсутствия слоя объемного заряда у боковой поверхности полупроводника, т. е. только в том случае, когда основным препятствием для рекомбинации являются переходы электронов и дырок на рекомбинационные уровни поверхностных состояний. Но при большой ширине приповерхностного объемного слоя и особенно большой высоте барьеров основным препятствием для рекомбинации может стать именно слой поверхностного заряда, который нс позволяет носителям достичь центров рекомбинации. Наличие обедненного слоя у поверхности зависит от параметров полупроводника (ширина запрещенной зоны) и состояния поверхности. Известно, что поверхность кремния окисляется на воздухе при комнатной температуре, а наличие слоя окисла у поверхности приводит к изгибу энергетических зон и появлению слоя объемного заряда. Германий же не окисляется на воздухе, обладает меньшей шириной запрещенной зоны, и следовательно, слой объемного заряда у поверхности германия оказывается меньшей ширины и обладает меньшей высотой барьера, чем у поверхности кремния.
Максимальное значение отношения Да^оо в настоящее время достигнуто на германиевых ГМР-элементах (0.1 при В=0.25 Тл). Достичь такой высокой чувствительности на кремниевых образцах можно только в области высоких температур (Т>450 К), при которых наступает собственная проводимость, т. е. выполняется условие по=ро;