Установка «ИЗОФАЗ ТМ — 200»

На Рис. П. 4.4, б представлена схема установки плазмохимического осаждения «ИЗОПЛАЗ ТМ». Рабочий стол с нагревателем до 800 «С и источником напряжения смещения на подложку; Неравномерность распределения температуры по длине рабочей зоны — не более ± 3 °C; Трехсекционный спиральный нагреватель с платиновой термопарой в каждой секции; На Рис. П. 4.3, б представлена схема реактора установки «МВУ ТМ… Читать ещё >
Установка «ИЗОФАЗ ТМ — 200» (реферат, курсовая, диплом, контрольная)
(к Главе 9, 10)
Установка «ИЗОФАЗ ТМ — 200»
На Рис. П. 4.1, а представлен общий вид вакуумной установки плазмохимического нанесения покрытий из газовой фазы с плазменной активацией в ВЧ-разряде «ИЗОФАЗ ТМ — 200», которая предназначена для получения покрытий из проводящих и диэлектрических материалов (SiOi, S13N4, Si, SiC), а также для формирования алмазоподобных плёночных структур и выращивания углеродных нанотрубок.

Рис. П. 4.1, и.
На Рис. П. 4.1,0 представлена схема установки плазмохимического нанесения «ИЗОФАЗ ТМ — 200».
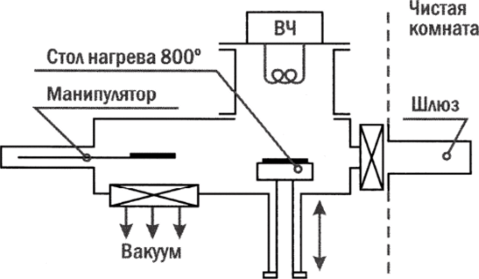
Рис. П. 4.1, 6
Особенности и характеристика:
- — источник плазмостимулированного газофазного осаждения (PECVD);
- — шлюзовая камера поштучной загрузки-выгрузки подложек или подложкодержателя диаметра — до 200 лш;
- — рабочий стол с нагревателем до 800 «С и источником напряжения смещения на подложку;
- — безмасляная система откачки на базе химически стойких турбомолекулярных и форвакуумных насосов;
- — микропроцессорная система управления;
- — возможность встраивания в «чистую» комнату;
- — возможность объединения в кластерный комплекс — стыковка отдельных установок через шлюзовую камеру или с платформой транспортно-загрузочного модуля;
- — неравномерность покрытий, но толщине ± 3%.
Установка «МВУ ТМ ИЗОФАЗА — CVD»
На Рис. П. 4.2, а представлен общий вид малогабаритной установки плазмохимического газофазного нанесения с плазменной активацией в ВЧ-разряде диэлектрических покрытий (Si02, Si3N4) «МВУ ТМ ИЗОФЛЗА — CVD».
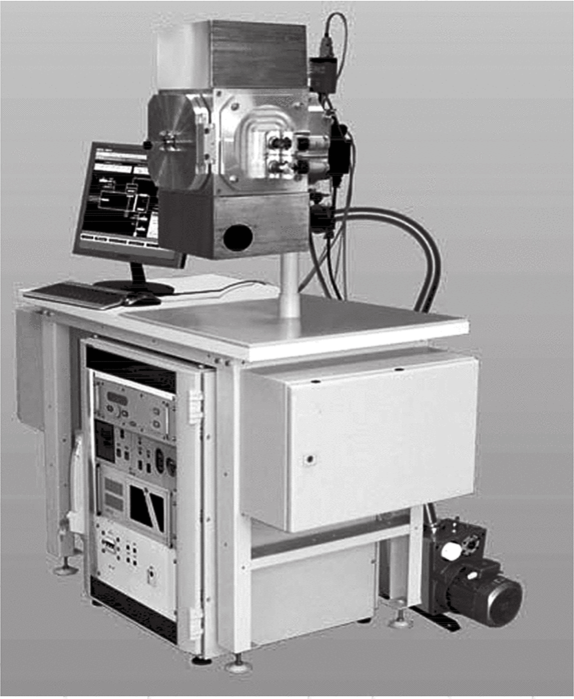
Рис. П. 4.2, и.
Схема реактора установки «МВУ ТМ ИЗОФАЗА — CVD» представлена на Рис. П. 4.2, б.
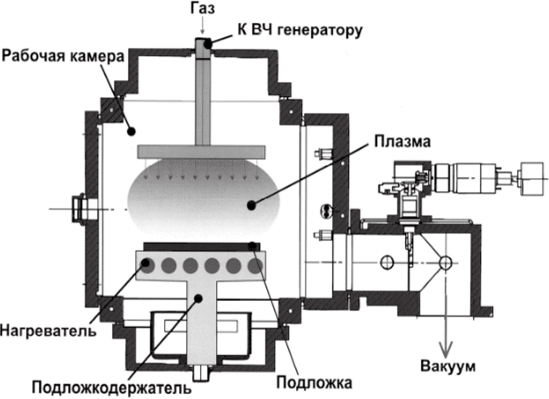
Рис. П. 4.2, б.
Особенности и характеристика установки:
индивидуальная обработка подложек диаметра — до 150 мм; откачка реактора до предельного разряжения 0,5 Па; поддержание стабильности ВЧ-разряда в диапазоне рабочих давлений 2…30 Па;
регулирование и автоматическое поддержание уровня ВЧ-мощносги в диапазоне 30…200 Вт; нагрев подложкодержателя до 350 °C;
автоматизированное управление от персонального компьютера; мощность потребления не более 3 кВт; занимаемая площадь — 1,5 м2;
возможна реализация процесса плазмохимического селективного травления при охлаждаемом нодложкодержателе.
Установка с ICP источником «МВУ ТМ ИЗОФАЗА — CVD 1СР»
На Рис. П. 4.3, а представлен общий вид малогабаритной установки плазмохимического газофазного нанесения с ICP источником «МВУ ТМ ИЗОФАЗА — CVD 1СР».

Рис. П. 4.3, а
На Рис. П. 4.3, б представлена схема реактора установки «МВУ ТМ ИЗОФАЗА — CVD 1СР».
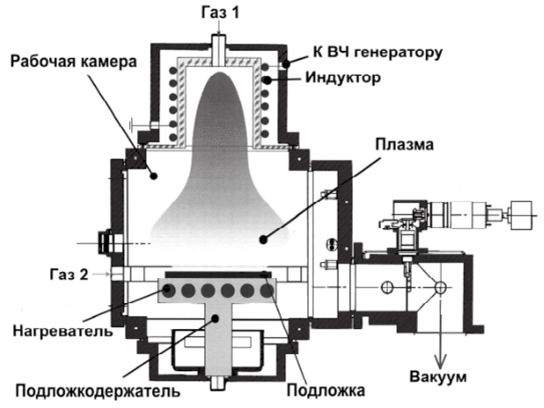
Рис. П. 4.3, б.
Особенности и характеристика установки:
- — плазмохимическое селективное и реактивно-ионное анизотропное травление при охлаждаемой подложке;
- — индивидуальная обработка подложек диаметра — до 100 мм;
- — реактор с источником ICP плазмы;
- — откачка реактора до предельного разряжения — 10'4 Па;
- — стабильность ВЧ-разряда в диапазоне давлений 0,5…5 Па;
- — изменение ВЧ смещения на ВЧ электроде-нодложкодержателе в диапазоне 0… 1000 В;
- — регулирование и поддержание ВЧ-мощности — 30…200 Вт;
- — нагрев подложкодержатсля до 400 «С;
- — автоматизированное управление от персонального компьютера;
- — мощность потребления не более 3 кВт.
Установка «ИЗОПЛАЗ ТМ»
На Рис. П. 4.4, а представлен общий вид установки плазмохимического осаждения диэлектрических покрытий при пониженном давлении «ИЗОПЛАЗ ТМ» для нанесения диэлектрических нелегированных и легированных слоёв оксида кремния (БЮз) и слоёв нитрида кремния (Si3N4) при пониженном давлении с плазменной активацией реагентов.

Рис. П. 4.4, а.
На Рис. П. 4.4, б представлена схема установки плазмохимического осаждения «ИЗОПЛАЗ ТМ».

Рис. П. 4.4, б.
Особенности и характеристика установки:
- — однорсакторная электропечь резистивного нагрева горизонтального типа;
- — кварцевый реактор с герметизируемой рабочей зоной;
- — ВЧ генератор с возможностью управления мощностью в рабочем режиме;
- — трехсекционный спиральный нагреватель с платиновой термопарой в каждой секции;
- — многоканальная газовая система с электронными регуляторами расхода газа, регуляторами давления и фильтрами тонкой очистки;
- — малогабаритная безмасляная химически стойкая форвакуумная система откачки;
- — система контроля герметизации реактора;
- — автономная система водяного охлаждения;
- — высокая скорость осаждения слоёв при низких температурах 250…400 °С;
- — высокая однородность осаждаемых слоёв;
- — низкий уровень радиационных повреждений;
- — микропроцессорная система управления;
- — возможность встраивания в «чистую» комнату;
- — внутренний диаметр реактора — 150 лш;
- — длина рабочей зоны реактора — 300 лш;
- — диаметр обрабатываемых пластин — до 100 лш;
- — кол-во одновременно обрабатываемых пластин — до 25;
- — диапазон рабочих температур — 300. .650 «С;
- — неравномерность распределения температуры по длине рабочей зоны — не более ± 3 °C;
- — нестабильность поддержания температуры в рабочей зоне — не более ± 1 °C;
- — время разогрева до 900 °C — не более 25 мин;
- — предельное остаточное давление в реакторе — не более 1,3 Па;
- — рабочее давление — 26,6… 133 Па;
- — электропитание (3 фазы, 380 В) — не более 7 кВт;
- — габаритные размеры — 1020×1600×1800 лш.