Экспериментальное исследование вольт-амперных характеристик двухбарьерных квантовых структур

Теперь можно вернуться к наиболее интересной для практики величине туннельного тока JRT. Из самых общих рассуждений можно заключить, что этот ток должен быть пропорционален интегральному потоку электронов, чья энергия совпадает с значениями энергий, для которых характерны большие коэффициенты пропускания. Другими словами, JRj пропорционален произведению высоты пика Ддах на его полуширину АЕхр… Читать ещё >
Экспериментальное исследование вольт-амперных характеристик двухбарьерных квантовых структур (реферат, курсовая, диплом, контрольная)
В [20] исследовались ВАХ структуры A! i_vGavAs-GaAsAli_*GavAs с различными соотношениями толщин барьеров и ямы. Эта гетеропара была выбрана по двум соображения. Во-первых, химические связи Ga и А1 с As практически идентичны, и ионы этих элементов имеют почти одинаковые размеры, что обеспечивает с большой точностью совпадение постоянных решетки данных соединений. Это дает возможность получать методом молекулярнолучевой эпитаксии очень однородные тонкие пленки с минимальным количеством дефектов как в самих пленках, так и на границах между ними, что является одним из главных условий наблюдения резонансного туннелирования. Вторым аргументом выбора послужил достаточно большой барьер на гетерогранице — порядка одного элекгрон-вольга при х = 1. Конфигурация одной из изготовленных таким образом структур показана на вставке (рис. 8.10).
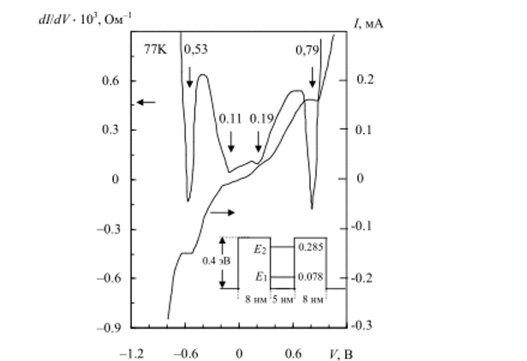
Рис. 8.10. Ток и дифференциальный кондактанс в зависимости от напряжения для структуры, энергетическая диаграмма которой приведена на вставке; стрелками у кривых показаны напряжения, соот-.
![Зависимость дифференциального кондактанса от приложенного напряжения для двухбарьерной структуры, показанной на вставке[20].](/img/s/8/28/1469228_2.png)
Рис. 8.11. Зависимость дифференциального кондактанса от приложенного напряжения для двухбарьерной структуры, показанной на вставке[20].
На рис. 8.11 приведена зависимость производной ВАХ структуры с равными толщинами барьеров и ямы.
Двухконтактная структура для измерения ВАХ представляла собой мезаструктуру диаметром 6 мкм с верхним контактным слоем из GaAs с концентрацией 1018 см-3. Такая же концентрация носителей заряда была в подложке. Разница в толщине и конфигурации этих двух частей структуры привела к определенной несимметричности ВАХ. Полярность напряжения показывает знак, относящийся к верхнему электроду. Для измерения кондактанса использовалось переменное напряжение, имеющее размах по амплитуде 2 мВ. Заметим, что в отличие от удельной проводимости кондактанс определяется как отношение тока к падению напряжения на образце. Таким образом, кондактанс представляет собой свойство образца конечных размеров, а не чисто внутреннюю характеристику материала.
Сравнивая рис. 8.10 и 8.11, видим, что обе кривые кондактанса похожи и характеризуются двумя парами особенностей (указаны стрелками). Легко заметить, что величины напряжений, отвечающих указанным особенностям, приблизительно вдвое больше значений, соответствующих положению уровней в ямах. Например, на рис. 8.10 удвоенная величина для первого уровня равна 0.156, для второго — 0.57, что хорошо соответствует среднему значению для двух полярностей напряжения — 0.15 и 0.66 В. Такое отклонение вполне объяснимо тем, что при расчете уровней использовались значение эффективной массы (0.1 массы свободного электрона) и высота барьера (0.4 эВ), предназначенные именно для оценки, а не для точных количественных вычислений.
Следующим важным вопросом является влияние температуры измерения на исследуемые процессы, которое легко анализировать по рис. 8.12. Прежде всего обращает внимание полное отсутствие каких-либо эффектов, связанных с туннелированием, на ВАХ, соответствующей комнатной температуре. Авторы [20] справедливо связывают это с температурным размытием локальных уровней в яме и невысоким барьером, который легко преодолевается электронами с относительно высокой для комнатной температуры энергией.
![Зависимость дифференциального коидактанса от приложенного напряжения для образцов с конфигурацией, соответствующей рис. 8.10 при 300, 77 и 4.2 К [20].](/img/s/8/28/1469228_3.png)
Рис. 8.12. Зависимость дифференциального коидактанса от приложенного напряжения для образцов с конфигурацией, соответствующей рис. 8.10 при 300, 77 и 4.2 К [20].
Хорошо видно, что с понижением температуры, когда практически исчезают перечисленные осложнения, отрицательная дифференциальная проводимость снова четко проявляется. Снижение температуры до 4.2 К не приводит к ожидаемому обострению особенностей, что, по-видимому, связано с наличием рассеяния на структурных флуктуациях и примесях. Это, в свою очередь, задает дополнительное уширение локальных уровней, которое необходимо всегда учитывать наряду с тепловым.
Таким образом, уже в ранних работах по исследованию резонансного туннелирования проявились две существенные задачи для будущих исследователей — резкость пика отрицательной дифференциальной проводимости и получение этого эффекта при комнатной температуре. Как первая, так и вторая даже при поверхностном взгляде должны быть связаны с совершенством и конструкцией эпитаксиальных тонкопленочных структур. Важную роль при этом должны играть и материалы, из которых формируется структура. Как развивались эти темы, проследим по работам [21,22].
Ток, протекающий через двухбарьерную структуру, по природе возникновения можно выразить суммой двух компонентов.

где Jrt — компонент резонансного туннелирования, a JEX — избыточный (или остаточный) компонент тока. Задача разработчика приборов сводится к созданию структуры с максимальным значением первого компонента и минимальным второго.
Из рассмотрения процесса туннелирования ясно, что одними из важнейших факторов, определяющих туннельный ток, являются величина коэффициента прозрачности D и его зависимость от приложенного напряжения. С точки зрения конструкции прибора эта зависимость, в свою очередь, определяется толщиной барьера и ямы (геометрический фактор) и высотой барьера (энергетический фактор). Последний задается соотношением ширин запрещенных зон материалов, составляющих структуру, и взаимным расположением их в энергетическом пространстве. Чаще всего этот так называемый разрыв зон обеспечивается в основном за счет зоны проводимости, гак что высоту барьера в первых работах полагали примерно равной разности энергий запрещенных зон.
Ток резонансного туннелирования создается электронами, чья энергия в направлении движения Ех лежит в диапазоне энергий, где коэффициент туннельной прозрачности достаточно велик. Результаты расчета этого коэффициента в зависимости от энергии электрона приведены на рис. 8.13. Двухбарьерная структура содержала барьеры AlAs толщиной 2.3 нм (8 атомных слоев) и квантовую яму толщиной 5, 7 и 9 нм.
Из рис. 8.13 видно, что Д, а следовательно, и ток JRT будут сильно зависеть от формы D (E).

Рис. 8.13. Схематическое изображение двухбарьерной структуры AlAs-GaAs-AlAs («) и зависимость коэффициента прозрачности от энергии электрона (б) полуширина пиков соответственно 180, 54 и 22 мкэВ для первых резонансов и 2900, 660 и 230 мкэВ для вторых [22].
Другими словами, величина тока зависит не только от амплитуды пика коэффициента прозрачности Д, но и от полуширины этого пика — АЕхр. Очень важным параметром, влияющим на JRT и JEx, являются величины энергии, соответствующие максимальному значению коэффициент прозрачности. Зависимости этих величин от толщины барьера и ширины ямы, рассчитанные в [21], показаны на рис. 8.14 и 8.15. При расчете авторы полагали, что высота барьеров равна разрыву зон.
Из рисунков видно, что энергия пика практически нс зависит от толщины барьера, но сильно зависит от ширины ямы, что соответствует выводам разд. 1.9. В то же время полуширина в меньшей степени определяется шириной ямы, но является сильной функцией толщины барьера.
Теперь можно вернуться к наиболее интересной для практики величине туннельного тока JRT. Из самых общих рассуждений можно заключить, что этот ток должен быть пропорционален интегральному потоку электронов, чья энергия совпадает с значениями энергий, для которых характерны большие коэффициенты пропускания. Другими словами, JRj пропорционален произведению высоты пика Ддах на его полуширину АЕхр (ширину на половине высоты). Это произведение получило название «окна» прозрачности. Согласно рис. 8.15 АЕхр экспоненциально уменьшается с ростом толщины барьера. Следовательно, для достижения значительных значении туннельного тока надо выбирать достаточно тонкие барьеры.
Избыточный ток JEx складывается из токов прямого (неупругого) туннелирования сквозь барьер и так называемого термоионного.
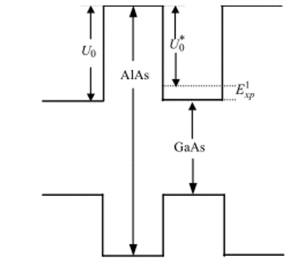
![Рис. 8.14. Результаты расчета энергии электронов, при которой должен наблюдаться пик коэффициента прозрачности для различных значений толщины барьера и ширины квантовой ямы для структуры AlAsGaAs-AlAs; цифрами 1 и 2 обозначены значения для первого и второго резонансных пиков [21].](/img/s/8/28/1469228_7.png)
Рис. 8.14. Результаты расчета энергии электронов, при которой должен наблюдаться пик коэффициента прозрачности для различных значений толщины барьера и ширины квантовой ямы для структуры AlAsGaAs-AlAs; цифрами 1 и 2 обозначены значения для первого и второго резонансных пиков [21].
![Полуширина первого и второго пиков коэффициентов прозрачности в функции толщины барьера для различных значений ширины квантовой ямы [21].](/img/s/8/28/1469228_8.png)
Рис. 8.15. Полуширина первого и второго пиков коэффициентов прозрачности в функции толщины барьера для различных значений ширины квантовой ямы [21].
тока — Jth• Особенно важен последний компонент, который складывается из электронов, проходящих над барьером, и электронов, туннелирующих через более высоко лежащие уровни в яме. Он вносит наибольший вклад в избыточный ток, и, обладая сильной температурной зависимостью, является главной причиной, приводящей к ослаблению (или полному исчезновению) эффекта ОДС при комнатной температуре. Для снижения JEx не- Рис. 8.16. Схема образова- обходимо создавать как можно бо- ния эффективного барьера.
лее высокий эффективный барьер для туннелирования.
Понятие «эффективный барьер» соответствует разности между высотой барьера, образованного разрывом запрещенных зон материалов, составляющих структуру, U0, и энергией первого уровня квантования в яме Ер (Uq=Uq ~ Ер) (рис. 8.16). Для рассматриваемого случая (AlAs-GaAs) структурный барьер примерно равен 1 эВ и может быть изменен только сменой контактирующих полупроводников.
Увеличения эффективного барьера можно достичь также снижением энергии Ферми электронов в контакте, снижая уровень легирования [23], но этот путь не очень хорош, так как при этом увеличивается сопротивление контактов.
Итак, на величину тока JRT влияют следующие факторы: а) толщина барьера; б) ширина ямы; в) высота барьера; г) концентрация примесей в области контактных областей. Если три первых фактора формируют величину пика и вид зависимости коэффициента прозрачности от энергии электрона, то четвертый определяет энергетическое распределение этих электронов на входе в двухбарьерную структуру.
Вклад этих факторов можно описать с помощью интеграла [22].

где Ех = (м*)/(2т*) — кинетическая энергия электронов, движущихся перпендикулярно к барьерному слою; k( = Jky + к — волновое число, характеризующее движение в плоскости, параллельной барьерам; D — коэффициент прозрачности; V- приложенное напряжение; Т — температура; Ер — энергия Ферми; F — функция, зависящая от распределения электронов в слое, прилегающем к барьеру (контакт).
Зависимость D (E) имеет резко выраженную пиковую форму для каждой резонансной энергии Е1хр (см. рис. 8.13). Это значит, что интеграл в (8.3.2) может быть вычислен только в малом интервале энергий в непосредственной близости от пика (±а). Этот диапазон определяется, таким образом, формой D (EX) и самой величиной Ехр, которые зависят от состава и размеров слоев исследуемой двухбарьерной структуры. Функция F определяется в основном примесной концентрацией в контактном слое.
Ранее на основании анализа зависимости коэффициента прозрачности от ширины ямы Lw [21] предсказывалось, что при увеличении Lw туннельный ток должен уменьшаться. Теперь ясно, что при этом понижается энергия первого (основного) резонансного пика Ер и увеличивается эффективный барьер Uq. Это, в свою очередь, вызывает обострение резонансного пика (уменьшение полуширины пика) и снижение резонансно туннельного тока.
Результаты расчетов туннельного тока в [22] сравнивались с экспериментными данными для структуры AlAs-GaAs-AlAs с AuGe контактами. Структура состояла из легированной n' Si (10IS см-3) подложки GaAs, 1 мкм n GaAs (8 • 1017см_3) элеюрода, слоя нелегированного GaAs (спейсер) 15 нм, затем структура с параметрами, указанными на рис. 8.13, а далее — снова нелегированный слой и электрод. Нелегированный слой вводился для ослабления влияния.
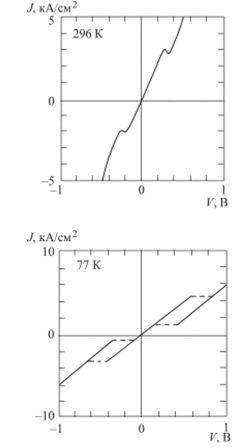
щие. 8.17. Вольт-ампсрная характеристика резонансно-туннельного диода для Lw= 7 нм примесей контакта на рассеяние в яме. Высокое легирование в контакте обеспечивало большой поток электронов и малое последовательное сопротивление.
Эксперимент показал наличие отрицательного дифференциального сопротивления для всех исследуемых структур, хотя для Lw ~ 9 нм этот эффект был выражен гораздо слабее. Для примера на рис. 8.17 приведена зависимость плотности тока от напряжения на структуре с Lw = 7 нм при температуре 296 и 77 К. Наиболее важным выводом из этого эксперимента было снижение пикового тока JP по мере увеличения ширины ямы.
Для проведения количественных сравнений с расчетными необходимо из экспериментального тока выделить ток туннелирования JRT, который рассчитывается по (8.3.2). Для этого следует вычесть из полного тока избыточный (паразитный !) ток JEX, соответствую щий напряжению для пикового тока. Применяемые термины для токов различных участков ВАХ легко понять из идеализированной зависимости тока от напряжения для прибора с ОДС, приведенной на рис. 8.18.

Рис. 8.18. Идеализированная вольт-амперная характеристика диодной двухбарьерной квантовой структуры Обычно предполагается, что избыточный ток растет линейно с ростом приложенного напряжения.
Это позволило авторам [22] считать, что значение этого тока, соответствующее напряжению VnHK9 будет равно примерно половине «тока долины» — Jy= Jmт, наблюдаемого экспериментально. Тогда Jrt = Jp — Jvft-
Полученные значения тока Jrt сравнивались с рассчитанными в зависимости от ширины ямы (рис. 8.19).
На рис. 8.20 показаны аналогичные зависимости для тока долины Jy (LVy Т). Хорошо видно, что ток долины Jv, во-первых, падает.

Рис. 8.19. Зависимость резонансно- Рис. 8.20. Зависимость тока дотуннельного тока от ширины квантолины от ширины ямы; толщина вой ямы: теоретические кривые — барьера 2.3 нм штриховые линии, рассчитанные дня высоты барьера Со = 0.956 эВ, штрихпунктирные — для Uo — 1.355 эВ [22]; значки — эксперимент с ростом ширины ямы (растет эффективный барьер), а во-вторых, значительно увеличивается с ростом температуры. Последнее хорошо согласуется с предположением, что главными составляющими этого тока являются туннельные потоки электронов, термически возбуждаемых до энергии вышележащих квантовых подзон в яме.