Оптическая и электросиловая микроскопия

Принцип работы атомно-силового микроскопа основан на регистрации силового взаимодействия между поверхностью исследуемого образца и зондом. В качестве зонда используется наноразмерное остриё, располагающееся на конце упругой консоли, называемой кантилевером. Сила, действующая на зонд со стороны поверхности, приводит к изгибу консоли. Появление возвышенностей или впадин под остриём приводит… Читать ещё >
Оптическая и электросиловая микроскопия (реферат, курсовая, диплом, контрольная)
История оптической микроскопии насчитывает не одно столетие. На сегодняшний день создано множество сложных оптических микроскопов. Однако возможности классической оптической микроскопии ограничены дифракционным пределом до, примерно, 1000-кратного увеличения.
Дифракционный предел — это минимальное значение размера пятна рассеяния, которое можно получить, фокусируя электромагнитное излучение. Меньший размер пятна не позволяет получить явление дифракции электромагнитных волн, которое проявляет себя как отклонение от законов геометрической оптики при распространении волн.
Минимальный дифракционный предел определяется формулой.

где X — длина электромагнитной волны в вакууме,.
п — показатель преломления среды.
Для дальнейшего повышения разрешения необходимо перейти на меньшие длины волн или учитывать фазовые характеристики излучения. Первый путь был реализован в электронных микроскопах, для получения изображений в которых используют электронный пучок с малыми длинами волн. Второй путь получил наибольшее развитие в интерференционной микроскопии, которая берет начало от интерферометров — измерительных приборов, в которых используется интерференция волн, то есть взаимное увеличение или уменьшение результирующей амплитуды двух или нескольких когерентных волн, одновременно распространяющихся в пространстве. В физике когерентностью называется скоррелированность (согласованность) нескольких колебательных или волновых процессов во времени, проявляющаяся при их сложении. Колебания когерентны, если разность их фаз постоянна во времени и при сложении колебаний получается колебание той же частоты.
Интерференционный микроскоп показан на рис. 5.2.

Рис. 5.2. Интерференционный микроскоп
Любой интерференционный микроскоп представляет собой сочетание оптического микроскопа и интерферометра. Для исследования поверхностных свойств объекта его помещают вместо одного из отражающих зеркал интерферометра. Изменение рельефа поверхности образца создает разность фаз между интерферирующими лучами, и помимо оптического изображения объекта наблюдается интерференционная картина. Обработка серии снимков позволяет восстановить фазовую картину и рельеф поверхности образца.
Основные этапы развития современной микроскопии следующие:
- 1981 г. — Сканирующая туннельная микроскопия. Дает атомарное разрешение на проводящих образцах.
- 1982 г. — Сканирующий ближнепольный оптический микроскоп. Дает разрешение 50 нм в оптическом изображении поверхности.
- 1984 г. — Сканирующий емкостной микроскоп. Реализует разрешение 500 нм в емкостном изображении.
- 1985 г. — Сканирующий тепловой микроскоп. Дает разрешение 50 нм в тепловом изображении поверхности.
- 1986 г. — Атомно-силовой микроскоп. Дает атомарное разрешение на непроводящих и проводящих образцах.
- 1987 г. — Магнитно-силовой микроскоп. Дает азрешение 100 нм в магнитном изображении поверхности.
- 1988 г. — Микроскоп на основе баллистической эмиссии электронов. Позволяет исследовать эффекты с нанометровым разрешением.
- 1989 г. — Ближнепольный акустический микроскоп для низкочастотныех акустических измерений с разрешением 10 нм.
- 1990 г. — Микроскоп, регистрирующий изменения химического потенциала.
- 1991 г. — Сканирующий зондовый микроскоп для измерения поверхностного потенциала с разрешением 10 нм.
- 1994 г. — Безапертурный ближнепольный оптический микроскоп с разрешением 1 нм.
Прорывом в развитии микроскопии стало изобретение сканирующего туннельного микроскопа и атомно-силового микроскопа (ACM), являющегося на сегодняшний день одним из самых распространенных инструментов исследования объектов с нанометровым разрешением. Его использование позволяет на атомном уровне анализировать поверхности многих материалов: полимерных пленок, кристаллов и биологических микрообъектов. На рис. 5.3 показано изображение атомарной решетки на графите размером 2*2 нм, полученное с помощью такого микроскопа.

Рис. 5.3. Изображение атомарной решетки на графите
ACM позволяет получать информацию не только о рельефе поверхности образца, но и о заряде, проводимости и магнитных свойствах исследуемой поверхности, при этом измерения могут проводиться в газах и в жидкости с атомным разрешением. Размер кадра обычно не превышает сотни микрон, а время получения изображения составляет от десятков секунд до нескольких минут.
В то же время интерференционный микроскоп позволяет получать изображения размером в тысячи микрон за доли секунды с нанометровым разрешением по вертикали и дифракционным ограничением в плоскости образца. В результате ACM (рис. 5.4) и интерференционный микроскоп дополняют друг друга как по временным, так и по пространственным параметрам исследования.

Рис. 5.4. Атомно-силовой микроскоп
Одним из основных элементов любого ACM является сканер — система перемещений образца или зонда при сканировании по трем координатам. Точность измерений в ACM напрямую зависит от точности его перемещений. Обычно сканер представляет собой пьезокерамическую трубку, для калибровки которой используют эталоны сравнения с известными размерными параметрами (рис. 5.5).
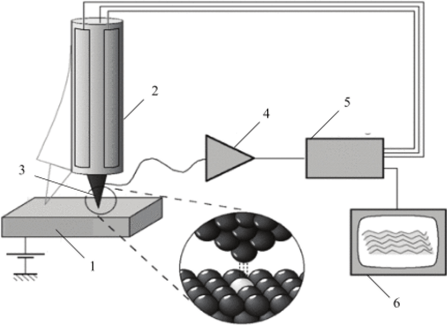
Рис. 5.5. Схема сканирующего туннельного микроскопа (СТМ):
- 1 — объект измерения; 2 — пьезокерамическая трубка; 3 — зонд-игла;
- 4 -усилитель туннельного тока; 5 — система управления и сканирования; б — регистрирующая система
В СТМ острая металлическая игла подводится к образцу на расстояние нескольких ангстрем (1А = Ю" 10 м — это приблизительный диаметр орбиты электрона в невозбуждённом атоме водорода и шаг атомной решетки в большинстве кристаллов). При подаче на иглу относительно образца небольшого потенциала возникает туннельный ток, то есть преодоление микрочастицей потенциального барьера в случае, когда её полная энергия меньше высоты барьера. Величина этого тока экспоненциально зависит от расстояния от образца до иглы. Типичные значения 1−1000 пА при расстояниях около 1 А.
В процессе сканирования игла движется вдоль поверхности образца, туннельный ток поддерживается стабильным за счёт действия обратной связи, и показания следящей системы меняются в зависимости от топографии поверхности. Такие изменения фиксируются, и на их основе строится карта высот. Другая методика предполагает движение иглы на фиксированной высоте над поверхностью образца. В этом случае фиксируется изменение величины туннельного тока и на основе данной информации идет построение топографии поверхности. Регистрирующая система фиксирует значение функции, зависящей от величины тока между иглой и образцом, либо перемещения иглы по оси Z. Обычно регистрируемое значение обрабатывается системой отрицательной обратной связи, которая управляет положением образца или зонда по одной из координат.
Однако даже на откалиброванном микроскопе при сканировании могут проявляться эффекты дрейфа и нелинейности. Таким образом, для высокоточных измерений необходимо проведение контроля перемещений в реальном времени.
Следующим шагом в развитии микроскопии стало изобретение атомно-силового интерференционного микроскопа (АСИМ). В отличие от сканирующего туннельного микроскопа, с помощью атомно-силового микроскопа можно исследовать как проводящие, так и непроводящие поверхности.
Технические характеристики АСИМ приведены в таблице 5.1 для двух типов исследований — атомно-силовых и интерференционных.
Таблица 5.1
Технические характеристики АСИМ
Характеристики. | Атомно-силовые. | Интерференционные. |
Разрешающая способность по горизонтали, нм. | 1−10. | |
Разрешающая способность по вертикали, нм. | 0.1. | |
Размер кадра, мкм*мкм. | 10*10. | 800*600. |
Разрешение изображений. пкс"пкс. | 512*512. | 2048*1536. |
Скорость получения кадров. | 0,01. | 0,1. |
Схема, поясняющая принцип работы АСИМ, представлена на рис. 5.6.
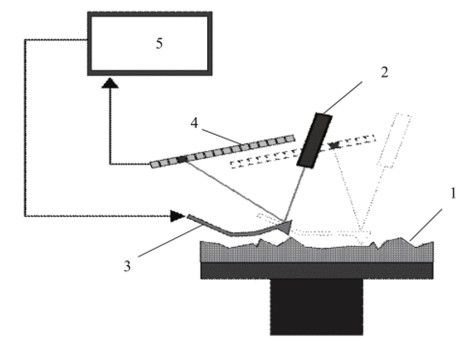
Рис. 5.6. Принцип работы атомно-силового микроскопа:
1 — объект измерения: 2-лазер: 3 ~ кантилевер: 4 — матрица фотодиодов: 5 — система управления и детектирования
Принцип работы атомно-силового микроскопа основан на регистрации силового взаимодействия между поверхностью исследуемого образца и зондом. В качестве зонда используется наноразмерное остриё, располагающееся на конце упругой консоли, называемой кантилевером. Сила, действующая на зонд со стороны поверхности, приводит к изгибу консоли. Появление возвышенностей или впадин под остриём приводит к изменению силы, действующей на зонд, а значит, и изменению величины изгиба кантилевера. Таким образом, регистрируя величину изгиба с помощью лазера и матрицы фотодиодов, можно сделать вывод о рельефе поверхности. Система лазер-матрица перемещается синхронно с кантилевером (показано пунктиром), при этом луч лазера, отражаясь от поверхности кантилевера, передает измерительный сигнал на фотодиоды для дальнейшей их обработки в системе детектирования.
Совмещение в одном приборе принципов интерференционной и атомно-силовой микроскопии дает расширенные возможности для исследования различных материалов на наноуровне.
В электросиловой микроскопии (ЭСМ) для получения информации о свойствах поверхности используется электрическое взаимодействие между зондом и образцом, между которыми подается постоянное напряжение, модулированное частотой со. Система зонд-образец обладает некоторой электрической емкостью. В процессе сканирования локальное расстояние между зондовым датчиком и поверхностью в каждой точке поддерживается постоянным, поэтому изменения амплитуды колебаний кантилевера на частоте 2© связаны с изменением емкости системы зонд-образец вследствие изменения диэлектрических свойств образца. С помощью этого метода можно изучать локальные диэлектрические свойства приповерхностных слоев образцов.
На рис. 5.7 показаны сравнительные результаты получения изображения углеродных трубок на подложке из полиимида с помощью ACM и ЭСМ.

Рис. 5.7. Изображения углеродных трубок с помощью ACM (а) и ЭСМ (6).
Магнитно-силовая микроскопия (МСМ) является разновидностью электросиловой микроскопии и применяется для исследования локальных магнитных свойств образцов. Для реализации метода на зонд наносится слой ферромагнитного материала. Для МСМ исследований, как правило, применяется двухпроходная методика. На первом проходе снимается АСМ-изображение рельефа. На втором проходе датчик перемещается на расстоянии Zq над поверхностью по траектории, повторяющей рельеф образца.
Расстояние Zo выбирается таким образом, чтобы сила Ван-дерВаальса, то есть сила межмолекулярного и межатомного взаимодействия, была меньше силы магнитного взаимодействия. Локальное расстояние между зондовым датчиком и поверхностью в каждой точке постоянно, поэтому изменения изгиба кантилевера в процессе сканирования связаны с неоднородностью магнитных сил, действующих на зонд со стороны образца.
На рис. 5.8 приведены изображения поверхности магнитного диска в нанодиапазоне соответственно после первого и второго прохода измерений.
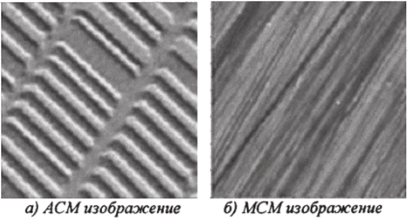
Рис. 5.8. Исследование поверхности магнитного диска
Для большинства таких измерительных систем характерно атомное разрешение, минимальный шаг сканирования от 0,01 до 0,001 нм, максимальный размер кадра не превышает 100×100 мкм. Подавляющее большинство зондовых приборов выпускается с целью решения задач микроскопии высокого разрешения, вплоть до атомного, и является наиболее эффективным методом изучения рельефа поверхности.
Нанооптика занимается изучением нанообъектов с помощью взаимодействия света с веществом. При этом используются два основных подхода: ограничение размеров источника или детектора света и ограничение области взаимодействия излучения с исследуемым образцом.
Источники излучения в обоих случаях помещаются на расстоянии нескольких нанометров от поверхности исследуемого образца. При передвижении такого нанометрового источника вдоль поверхности регистрируется оптическое изображение или картина взаимодействия излучения с веществом с разрешением, ограниченным размерами источника или областью взаимодействия излучения с образцом.
Ближнепольная оптическая микроскопия — это оптическая микроскопия, обеспечивающая разрешение лучшее, чем у обычного оптического микроскопа. Повышение разрешения достигается детектированием рассеяния света от изучаемого объекта на расстояниях меньших, чем длина волны света.
Типичные схемы экспериментальных установок для апертурной микроскопии ближнего поля с использованием волокна в качестве источника излучения и детектора представлены на рис. 5.9.
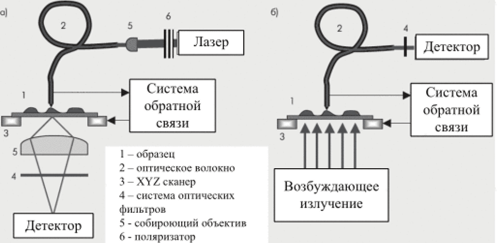
Рис. 5.9. Схемы апертурной микроскопии ближнего поля: а) ближнее поле используется в качестве возбуждающего поля, б) регистрируется ближнее поле флуоресцирующего образца