Мощные GaN и SiC транзисторы

Известно, что силовые приборы имеют ограничение на рабочее напряжение, обусловленное низкой пробивной напряженностью. По сравнению с Si, MOSFET на SiC должны иметь выше, более чем в 10 раз, пробивную напряженность поля и в 400 раз ниже удельное сопротивление в открытом состоянии, что делает его «идеальным» материалом для силовых полупроводников. Структурно можно выделить несколько типов MOSFET… Читать ещё >
Мощные GaN и SiC транзисторы (реферат, курсовая, диплом, контрольная)
Активно осваиваются сегодня и полупроводниковые материалы с широкой ДЕ, что обеспечивает большие значения пробивного и рабочего напряжения, высокую мощность и рабочую температуру перехода. Это направление наиболее важно для микроволновой электроники, однако промышленностью развиваются всего два широкозонных полупроводниковых материала — GaN и SiC.
GaN, как и вся группа Ш-нитридов, представляется наиболее перспективным широкозонным полупроводниковым материалом, совокупность свойств которых с возможностью формирования на нем гетеропереходов позволяет добиться уникальных характеристик транзисторов — рабочего напряжения свыше 60 В, частот до 70 ГГц, мощности до 200 Вт. GaN-HEMT уже продемонстрированы с выходной мощностью свыше 176 Вт, рабочим напряжением 63 В, КПД 54% при усилении 12,9 дБ на частоте 2,1 ГГц. Рекордное на сегодня значение удельной мощности для них — 32,2 Вт/мм при КПД 54,8%, рабочем напряжении 120 В и частоте 4 ГГц.
SiC всего лишь несколько лет назад стал рассматриваться в качестве материала для приборов полупроводниковой (особенно силовой) электроники. Поэтому сегодня лишь две компании производят приемлемые изделия из SiC — диоды с барьером Шоттки (ДБШ) с рабочим напряжением 300—1200 В и током 1—20 А на кристалл. Уже сейчас применение SiC ДБШ с напряжением 600 В совместно с CoolMOS Si-полевыми транзисторами позволяет получить выигрыш в два раза по эффективности в преобразователях с жестким режимом переключения по сравнению с другими ключевыми приборами.
Из существующих 170 известных политипов SiC только два доступны для серийного изготовления приборов — это 4H-SiC и 6H-SiC. В табл. 5.1 приводится сравнение основных электронных свойств 4H-SiC с Si и GaAs полупроводниковыми материалами.
Основные преимущества SiC перед с Si и GaAs:
- — более чем на порядок выше Unp 4H-SiC, чем у Si и GaAs (это значительно снижает сопротивления в открытом состоянии R0T). На рис. 5.20 показана зависимость R0T от напряжения пробоя кристалла. Низкое удельное R0T, в сочетании с высокой плотностью тока и теплопроводностью позволяет уменьшать размеры кристаллов для силовых приборов;
- — большая ширина АЕ является результатом более высокого барьера Шоттки по сравнению с Si и GaAs, что дает малый ток утечки (менее 70 мкА при 200 °С), а при повышенной температуре кристалла снижает термоэлектронную эмиссию за пределами барьера;
- — высокая теплопроводность SiC снижает тепловое сопротивление кристалла;
- — высокая надежность и стабильность во времени приборов на основе SiC (свойства слабо зависят от температуры);
- — SiC устойчив к жесткой радиации;
- — рабочая температура кристалла более 600 °C позволяет создавать приборы для жестких и специальных условий эксплуатации.
Таблица 5.7.
Сравнительная таблица основных свойств полупроводниковых материалов 4H-SiC с Si и GaAs.
Наименование. | Si. | GaAs. | 4H-SiC. |
Ширина запрещенной энергетической зоны ДЕ, эВ. | 1,12. | 1,5. | 3,26. |
Подвижность электронов см2/с-В. | |||
Подвижность дырок цр, см2/с-В. | |||
Концентрация собственных носителей, см-3 при 300 К. | 1,5−1010 | 2,1-Ю6 | 5.T109 |
Скорость объемного заряда электронов, см/с-107 | 1,0. | 1,0. | 2,0. |
Критическая напряженность электрического поля, МВ/см. | 0,25. | 0,3. | 2,2. |
Теплопроводность, Вт/см-К. | 1,5. | 0,5. | 3,0—3,8. |
ДБШ на SiC в настоящее время являются единственным коммерчески доступным продуктом и обычно имеют структуру, приведенную на рис. 5.21. Высота барьера 4H-SiC при металлизации Ti и Ni составляет 0,8 В и 1,3 В соответственно (Ni — металлизация для высоковольтных (более 1500 В) диодов, Ti — для низковольтных).
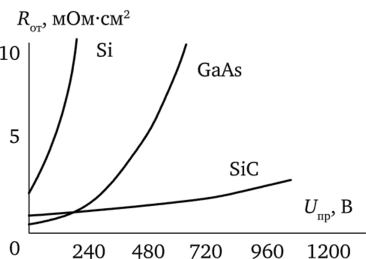
Рис. 5.20. Зависимость Rot от напряжения пробоя кристалла Типовые зависимости для прямого падения напряжения от тока при различных температурах Si и SiC серийно выпускаемых диодов показаны на рис. 5.22.
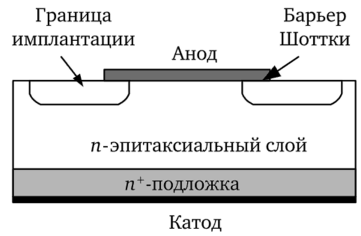
Рис. 5.21. Структура ДБШ на SiC.

Рис. 5.22 ВАХ при различных температурах Si и SiC.
Поскольку с ростом температуры у SiC снижается р,2 и повышается удельное сопротивление в открытом состоянии, прямое падение напряжения, в отличие от Si ДБШ, имеет положительный температурный коэффициент.
Известно, что силовые приборы имеют ограничение на рабочее напряжение, обусловленное низкой пробивной напряженностью. По сравнению с Si, MOSFET на SiC должны иметь выше, более чем в 10 раз, пробивную напряженность поля и в 400 раз ниже удельное сопротивление в открытом состоянии, что делает его «идеальным» материалом для силовых полупроводников. Структурно можно выделить несколько типов MOSFET — это DMOS, UMOS и JFET приборы. DMOS —Double-implanted MOS (рис. 5.23, а — SiC DMOS-транзистор) — аналогичен кремниевому double-Diffused MOS, у которого области p-базы и п + -истока получают ионной имплантацией. В этих приборах положительное смещение на затворе из поликристаллического Si создает инверсный слой на границе раздела между Si02 и SiC р-типа. Электроны протекают из п + -истока через инверсный слой в п-область дрейфа и затем в п ±подложку (сток).
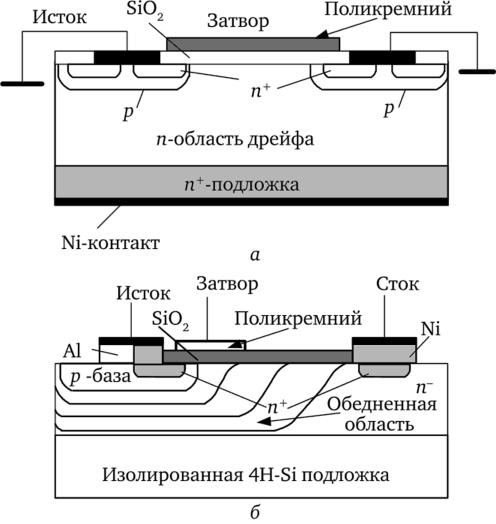
Рис. 5.23. SiC DMOS-транзистор (a), Lateral DMOSFET (б) Широкая примесная п-область обеспечивает высокую электрическую прочность прибора в закрытом состоянии, а максимальное рабочее напряжение транзистора будет определяться толщиной области дрейфа и концентрацией примеси в ней. Поскольку максимальная толщина эпитаксиального слоя коммерчески доступных SiC подложек не превышает 10 мкм, напряжение ограничивается величиной 1,6 кВ. Один из путей его повышения — использование горизонтальной структуры или LDMOS (рис. 5.23, б — Lateral DMOSFET).
Здесь в структуре создается обедненная область, которая в закрытом состоянии транзистора при увеличении потенциала также увеличивается и, достигнув изолированной подложки, продолжает распространяться в сторону стока, блокируя приложенное между стоком и истоком напряжение. При этом максимальное напряжение не зависит от толщины эпитаксиального слоя и ограничивается только уровнем начала поверхностного электрического пробоя между электродами (для LDMOSFET (Cree Inc.), уровень напряжения пробоя составляет 10 кВ).
Для снижения удельного сопротивления в открытом состоянии у UMOS-транзисторов затвор выполняется в форме [/-образной «канавки» («trench-gate», рис. 5.24 — SiCUMOS-транзистор).
На данном рисунке показаны диаграммы распределения электрического поля в р-п-переходе и на MOS-структуре. Можно видеть, что в области оксидной изоляции затвора наблюдается скачок потенциала, превышающий пиковую напряженность поля в полупроводнике в 2,5 раза. Это приводит к необратимым пробоям в транзисторе и накладывает ограничение на величину рабочего напряжения.
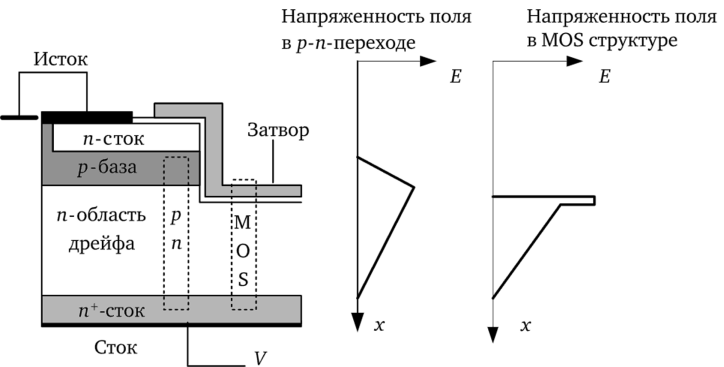
Рис. 5.24. SiCUMOS-транзистор.
Решение этой проблемы предложено центром Purdue University WBG Research Group, которым создана структура с «интегральной защитой», ограничившей напряженность поля в оксидном слое затвора и одновременно снизившей удельное сопротивление в открытом состоянии (рис. 5.25 — SiC ACCUFET-транзистор).
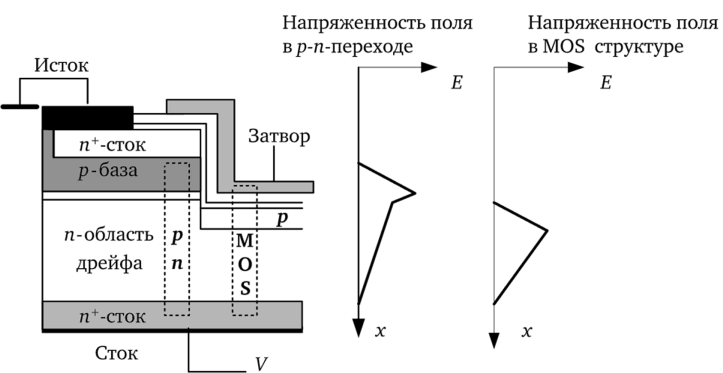
Рис. 5.25. SiC ACCUFET-транзистор.
В прибор введена дополнительная область p-типа, расположенная под «канавкой» затвора, позволяющая снизить напряженность поля на границе раздела оксид/полупроводник до нуля, защищая тем самым оксид от пробоя в закрытом состоянии. Дополнительный эпитаксиальный слой под p-базой предотвращает отсечку канала проводимости в открытом состоянии и способствует протеканию тока в область дрейфа. Прибор также включает в себя обогащенный п-эпитаксиальный слой, выращенный на боковой стенке «канавки». Этот слой превращает прибор в так называемый «MOSFET с обогащенным слоем» — accumulationlayer MOSFET или «ACCUFET», у которого увеличена цп и одновременно снижено удельное сопротивление в открытом состоянии. Полученные образцы ACCUFET обеспечивают максимальное напряжение 1,4 кВ, удельное сопротивление 15,7 МОм-см и добротность 125 МВт/см, что в 25 раз превышает теоретический предел для Si MOSFET.
Рассмотренные приборы имеют высокую, но не всегда достаточную степень готовности для начала серийного производства. В отличие от MOSFET полевые транзисторы с управляющим р-п-переходом и каналом p-типа (рис. 5.26 — SiC JFET-транзистор) отработаны до уровня серийного производства и появление их на рынке силовых полупроводников можно ожидать в ближайшее время.
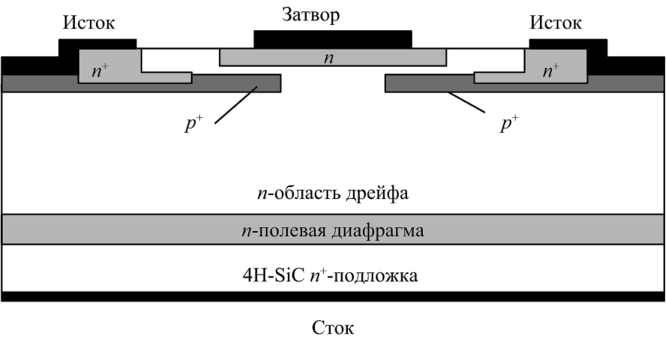
Рис. 5.26. SiC JFET-транзистор.
Недостатком JFET является то, что при пусковом напряжении на затворе транзистор полностью открыт. Свободна от этого недостатка каскодная схема, состоящая из высоковольтного SiC JFET и низковольтного Si MOSFET-транзисторов. Такой гибридный прибор управляется как обычный MOSFET, при этом обеспечивается значительно более низкое сопротивление в открытом состоянии и высокое рабочее напряжение.
На рис. 5.27 показана схема каскада с высоковольтным SiC JFET и низковольтным Si MOSFET, разработанная исследовательским центром SiCED (SIEMENS AG).
На рис. 5.28 приведен сравнительный график зависимости плотности тока и прямого падения напряжения от удельного сопротивления в открытом состоянии для SiCи Si-транзисторов.
Можно видеть, что SiC JFET с напряжением 3,3 кВ имеет потери проводимости ниже, чем Si CoolMOS™ с напряжением 600 В.
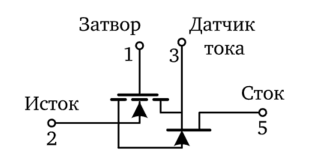
Рис. 5.27. Схема каскада с высоковольтным SiC JFET и низковольтным Si.
MOSFET транзисторами.
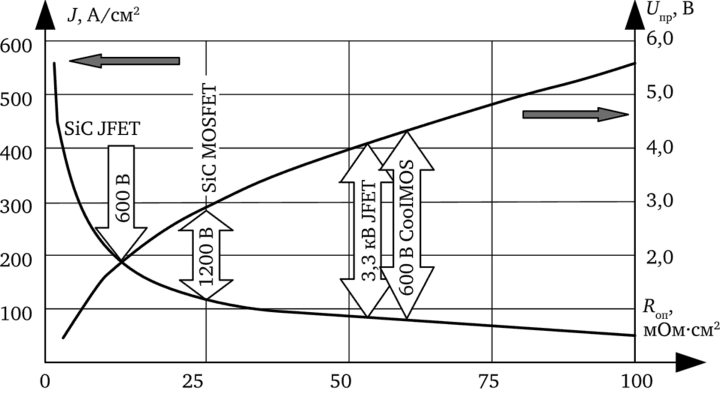
Рис. 5.28. График зависимости J и (Упр от /?оп для SiC, Si-транзисторов Для построения высоковольтных ключей можно использовать схему «супер каскада» — линейку из последовательно включенных SiC IFET и управляющего низковольтного Si MOSFET-транзисторов, как показано на рис. 5.29 (каскодный ключ 9 кВ, 1,3 Ом из SiC JFET с Ucn = 3 кВ и Si MOSFET Ucll = 55 В).
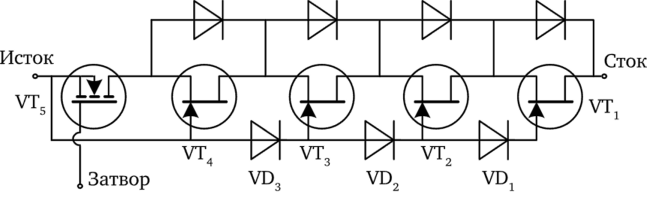
Рис. 5.29. Каскодный ключ.
В настоящее время основными управляемыми приборами силовой электроники в области коммутируемых токов до 50 А и напряжений до 500 В являются биполярные транзисторы (ВРТ) и идущие им на смену полевые транзисторы с изолированным затвором.
(MOSFET). Нишу высоковольтных силовых приборов с большими уровнями токов и напряжениями (до единиц киловольт) заняли биполярные транзисторы с изолированным затвором (IGBT — Insulated Gate Bipolar Transistor).
MOSFET-транзисторы появились в 1980;х годах, но и сегодня высоковольтных MOSFET-транзисторов с качественными характеристиками создать пока не удается, так как сопротивление канала открытого транзистора растет пропорционально квадрату напряжения пробоя.
IGBT-прибор представляет собой биполярный р-п-р-транзистор, управляемый от низковольтного MOSFET-транзистора с индуцированным каналом (рис. 5.30).
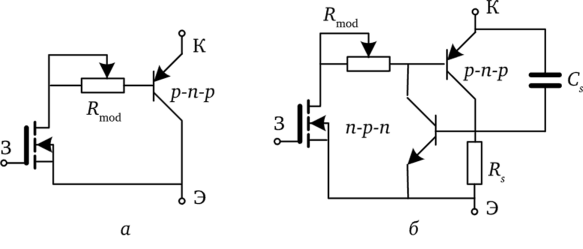
Рис. 5.30. IGBT-прибор.
Потери IGBT-приборов растут пропорционально току, а не квадрату тока, как у полевых транзисторов. Максимальное напряжение IGBTтранзисторов ограничено только технологическим пробоем и сегодня выпускаются приборы с рабочим напряжением до 4 кВ, при этом остаточное напряжение 2—3 В. По быстродействию силовые IGBT-приборы уступают MOSFET, но превосходят биполярные.
Структура базовой IGBT-ячейки представлена на рис. 5.31, а и содержит в стоковой области дополнительный р + -слой, образующий р-п-р- биполярный транзистор с очень большой площадью (для коммутации значительных токов). При закрытом состоянии структуры внешнее напряжение приложено к обедненной области эпитаксиального п—слоя. При подаче на изолированный затвор положительного смещения возникает проводящий канал в p-области (на рис. 5.31, а обозначен пунктирной линией) и включается соответствующий МДПтранзистор, обеспечивая открытие биполярного р-п-р-транзистора. Между внешними выводами коллектора и эмиттера начинает протекать ток. При этом ток стока МДП-транзистора оказывается усиленным в ((3 + 1) раз. При включенном биполярном транзисторе в л~-область идут встречные потоки носителей, что ведет к падению сопротивления этой области и дополнительному уменьшению остаточного напряжения на приборе.
Напряжение на открытом приборе складывается из напряжения на прямосмещенном эмиттерном переходе р-п-р-транзистора (диодная составляющая) и падения напряжения на сопротивлении модулируемой n-области (омическая составляющая):

где Кмдп — сопротивление MOSFET-транзистора в структуре IGBT (сопротивление эпитаксиального п—слоя); (3 — коэффициент передачи базового тока биполярного р-п-р-транзистора.
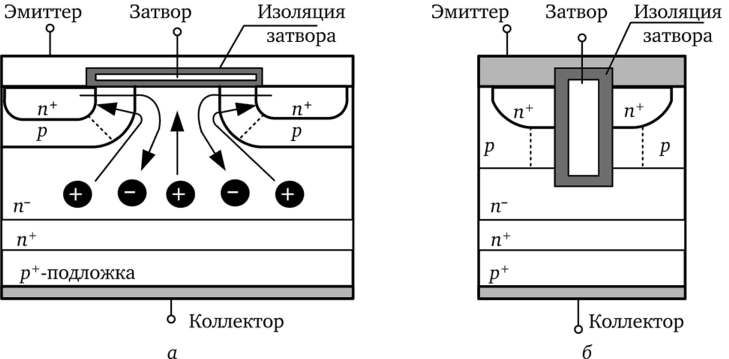
Рис. 5.31. Структура базовой IGBT-ячейки (о); IGBT-транзистор с вертикальным затвором (б).
В настоящее время для уменьшения падения напряжения на IGBTтранзисторах в открытом состоянии, расширения диапазонов допустимых токов, напряжений, области безопасной работы они изготавливаются по технологии с вертикальным затвором — trench-gate technology (рис. 5.31, б). При этом размер элементарной ячейки уменьшается в 2—5 раз.
Типичные значения времени рассасывания накопленного заряда и спада тока при выключении IGBT находятся в диапазонах 0,2—0,4 и 0,2—1,5 мкс соответственно. Область безопасной работы современных IGBT-транзисторов позволяет успешно обеспечить их надежную работу без применения дополнительных цепей формирования траектории переключения при частотах от 10 до 20 кГц.
Типовые выходные ВАХ IGBT-транзисторов приведены на рис. 5.32.
Следует отметить, что IGBT-транзисторы не так чувствительны к электростатическому пробою, как, например, КМОП-приборы, однако производить монтажные работы с ними необходимо в антистатическом браслете, а для защиты затвора от статического пробоя в схеме необходимо подключать параллельно цепи затвор-эмиттер резистор сопротивлением 10—20 кОм.

Рис. 5.32. Выходные ВАХ IGBT-транзисторов.
Условные графические обозначения IGBT-транзисторов, используемые различными производителями на принципиальных схемах электронных устройств, приведены на рис. 5.33.
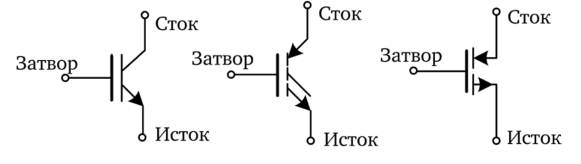
Рис. 5.33. Условные графические обозначения IGBT-транзисторов.
Компания International Rectifier (IR) выпускает четыре семейства IGBT силовых транзисторов. Разделение по классам идет по диапазону рабочих частот. Так выделяют семейства Standart, Fast, UltraFast, Warp (табл. 5.2). Транзисторы семейства Standart оптимизированы по минимуму падения напряжения на ключе и статическим потерям, а транзисторы семейства UltraFast и Warp оптимизированы (для ВЧ-цепей) по минимуму динамических потерь. Малая энергия переключения позволяет использовать транзисторы Warp вплоть до частот 150 кГц, а транзисторы UltraFast — до 60 кГц при приемлемом уровне динамических потерь.
Жесткие условия эксплуатации могут касаться и температурного режима, в котором SiC практически незаменим. Это заставляет разработчиков интенсивно вести исследования в области SiC-технологий. Наиболее сложным остается вопрос получения надежного электрического контакта (поскольку при Т > 500 °C металлизация контакта деградирует из-за взаимной диффузии между слоями, окисления контакта и композиционных и микроструктурных изменений на границе раздела металл-полупроводник). Варианты с вакуумированием многократно увеличивают стоимость, габариты, делая непригодным к широкому применению.
Таблица 5.2
Сравнительные характеристики различных семейств IGBT-транзисторов компании IR.
Параметр | Семейства IGBT-транзисторов. | |||
Standart. | Fast. | UltraFast. | Warp. | |
1,3. | 1,5. | 1,8. | 2,1. | |
Энергия переключения, мДж/А мм2 | 0,54. | 0,16. | 0,055. | 0,03. |
Статические потери, Вт. | 0,625. | 0,75. | 0,95. | 1Д. |
Применение трехслойной металлизации политипа 6H-SiC Ti (100 нм)/ TaSi2 (200 HM)/Pt (300 нм) позволяет добиться температурной стабильности ВАХ и омического сопротивления контакта на воздухе в течение более 600 часов при 500 °C. Особенностью такого контакта является то, что первоначальное окисление Si создает механизм образования критического диффузионного барьера, предотвращающего дальнейшее проникновение кислорода в слой металлизации. Такое решение предложено центром NASA (Glenn Research Center) и делает возможным создание высокотемпературных приборов в экономичных либо в бескорпусных вариантах.
Важным направлением является и создание SiC интегральных схем, при этом наибольший интерес представляет SiC CMOS-технология, обеспечивающая низкую потребляемую мощность, высокую радиационную и тепловую стойкость. Первая SiC CMOS ИС была представлена компанией Cree Research в 1996 году, однако проблемы, связанные с высоким пороговым напряжением р-MOSFET-транзисторов не позволили использовать данную технологию для серийного производства.
Но все достоинства SiC-структур, даже в частотном диапазоне менее 6 ГГц, разбиваются о чрезвычайно высокую стоимость SiC-пластин (табл. 5.3). Проблема эта актуальна не только для SiC-транзисторов, но и для всех мощных приборов на основе широкозонных полупроводников. Действительно, большая плотность мощности означает малую площадь теплосъема, что требует применения подложек с высокой теплопроводностью. Один из лучших с этой точки зрения материалов — SiC. Поэтому сегодня практически все GaN-приборы с рекордными характеристиками выполнены именно на SiC-подложках.
По состоянию на 2004 год, 85% рынка SiC-подложек принадлежало компании Сгее, которая первой начала производство 4H-SiC-miacTHH, используемых главным образом для изготовления светодиодов. Подложки 6H-SiC в США в промышленном масштабе производит только компания с необычным названием II—VI. При этом стоимость 75-миллиметровой полуизолирующей SiC-пластины колеблется от 4 до 5 тыс. долл. К началу 2005 года первые шаги на коммерческий рынок SiC-пластин сделали еще несколько компаний — DowCorning (США), SiXon (Япония), SiCrystal (Германия) и Okmetic (Финляндия). А фирмы Сгее и II—VI объявили о запуске линий изготовления 100-миллиметровых SiC-пластин, но все это пока не изменило ценовой ситуации.
Таблица 5.3
Подложки для приборов на широкозонных полупроводниках.
Материал. | 4HSIC. | AIN. | GaN. | GaAs. | Si. |
Ширина ДЕ, эВ. | 3,26. | 6,2. | 3,36. | 1,42. | 1,12. |
Теплопроводность, Вт/(см-К). | 4,9. | 3,4. | 1,3. | 0,6. | 1,3. |
Напряженность поля пробоя, МВ/см. | 4,9. | 3,4. | 1,3. | 0,6. | 1,3. |
Диаметр производимых пластин, мм. | |||||
Цена пластин, долл./дюйм2 | > 1000. | > 1000. | < 10. | ~1. |
Ситуация с ценой на GaN-подложки не проще, хотя он и уступает по теплопроводности SiC, но в качестве подложки для GaN-приборов предпочтителен благодаря структурному соответствию. Сегодня проводящие GaN-подложки, диаметром не более 50 мм, производят лишь три компании — ATMI, Куша, Sumitomo, но цены их высоки, число пластин ограничено, а их плотность дефектов не отвечает требованиям, предъявляемым к пластинам для крупномасштабного производства. Положение с полуизолирующими GaN-подложками еще сложнее.
AIN-пластины в промышленных масштабах во всем мире производит только компания Crystal IS (США) и только диаметром 25 мм. Надежда, что в скором времени это положение изменится, имеется, тем более, что ведутся активные работы по созданию подложек на основе искусственных алмазов.
В то же время значимые успехи достигнуты в области создания GaNприборов на недорогих Si-подложках с кристаллографической ориентацией. Лидером освоения и коммерциализации GaN-эпитаксиальных структур на таких подложках выступила компания Nitronex. На ее подложках фирма TriQuint Semiconductor уже создала МИС двухкаскадного усилителя Х-диапазона мощностью 25 Вт. Ширина затвора транзистора в выходном каскаде составляет 11,4 мм, размер кристалла — 3×4,5 мм. Мощность 25 Вт в импульсном режиме была достигнута на частоте 10 ГГц при напряжении стока 30 В и усилении 15 дБ, КПД — 21%.
В заключение следует сказать и о технологиях, которые с определенной уверенностью можно отнести к разряду разрабатываемых в ближайшей перспективе.